 在新能源汽车、光伏逆变器、充电桩等高功率应用场景中,SiC(碳化硅)器件正加速替代传统硅器件,成为提升系统效率和功率密度的核心。其高压、高速、高温的性能优势,也对制造与测试流程提出更高要求。 然而,一颗SiC芯片真正进入系统应用之前,需要经历复杂的制造与筛选流程。测试节点的时机与手段,不仅关乎性能验证,更决定了制造成本的高低。 1.为什么测试要尽早? SiC芯片对晶体缺陷和工艺窗口极其敏感,微裂纹、边缘击穿、漏电通道、热应力引发的故障等问题,往往在封装后才会暴露。一旦问题芯片进入封装流程: ● 成品报废,材料与工时成本浪费; ● 品质风险上升,客户退货及口碑受损; ● 产线节奏被打乱,增加额外返工负担。 因此,尽早识别缺陷芯片,是控制成本、保障良率的关键。 2.圆级测试:从“检查”到“预防” 晶圆级测试在芯片封装前进行,目标是在投入昂贵封装工艺前剔除缺陷芯片。
一句话总结:晶圆级测试是“预防”,封装级测试是“诊断”。而预防的成本,永远低于诊断。 3.晶圆级老化测试(WLBI):失效筛选的关键 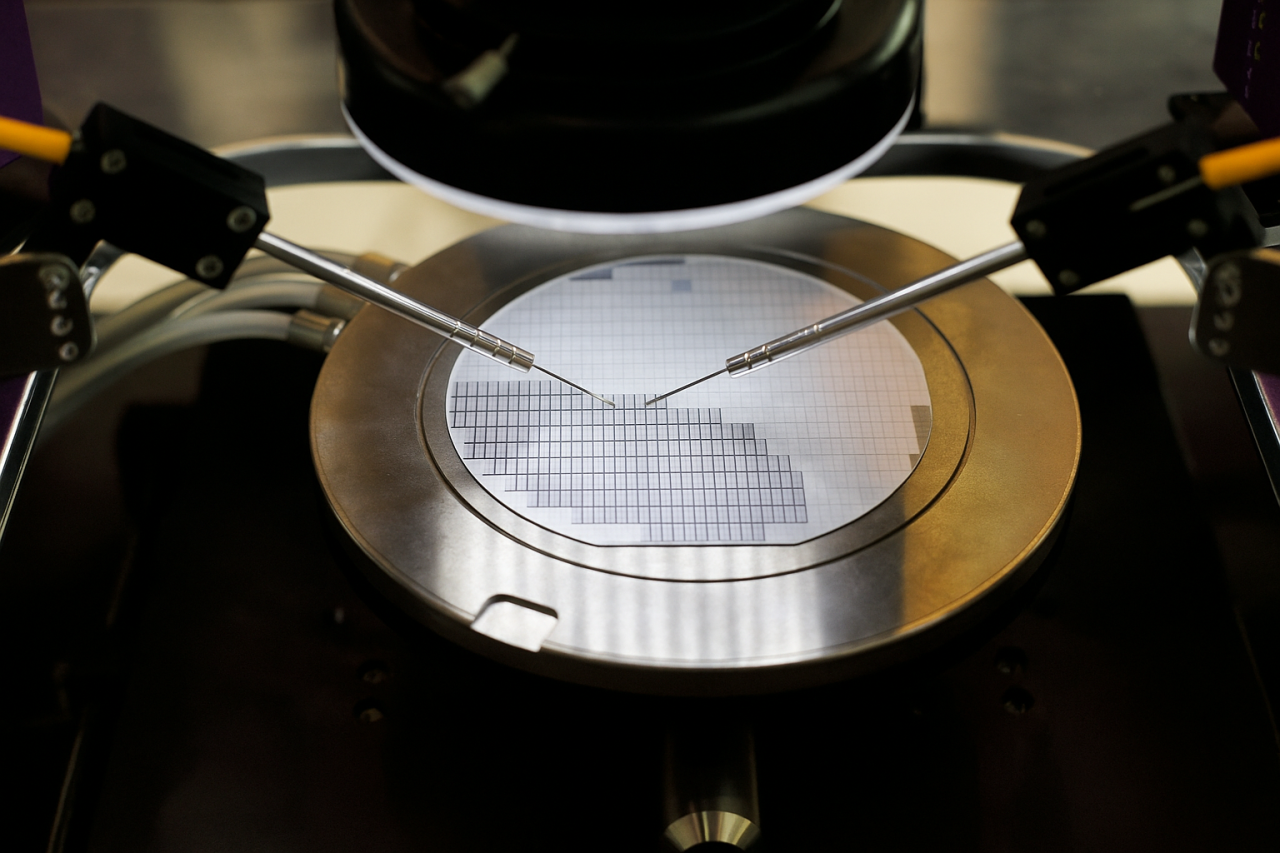 SiC芯片不仅要“早测”,还要“应力测”。 针对SiC器件更高的失效敏感性,晶圆阶段的老化测试测试(即WLBI)显得尤为重要。通过在裸片阶段模拟高温、高压等工作环境进行加速老化,可有效提前筛选早期失效芯片,提升系统级可靠性。 在这个阶段进行Burn-In,不仅能提高最终良率,更有助于客户实现裸片交付模式 —— 裸片交付、免测集成。 4.忱芯科技WLBI测试解决方案: 专为SiC而生的晶圆老化测试平台 作为专注于功率半导体测试设备的研发制造厂商,我们意识到:SiC的兴起,不仅是材料工艺的革新,更是测试体系的全面升级。 忱芯科技推出的ACHESON 系列6/8英寸全自动晶圆老化测试设备,专为SiC而生,能够在晶圆阶段模拟高应力老化场景,为客户提前筛选潜在风险芯片,帮助建立高效稳定的裸片交付体系。 在高压大电流应力测试、探针接触一致性、信号干扰控制等方面,我们系统具备完整的工程能力,并支持客户柔性配置测试参数与接口。  SiC MOSFET晶圆级动态WLBI测试系统 ● 应用于6,8 英寸SiC MOSFET晶圆老化测试 ● 全自动上下料,全自动搬运 ● 系统具备芯片测试能力,包含Vth测试,栅漏电电流测试,漏极漏电流测试,GB/RB测试 ● 支持后期升级动态老化测试 总结 ● SiC芯片需在晶圆阶段完成“第一轮考试”,早期测试可避免后期高额损失; ● 晶圆级老化测试(WLBI)是提升产品良率与可靠性的关键手段; ● 测试不仅是质量控制的环节,更应成为成本管理和良率提升的核心策略。 忱芯科技致力于功率半导体全生命周期测试解决方案,涵盖晶圆测试、老化筛选、封装电性检测等全流程,助力客户打造“零缺陷、高可靠”的产品体系。 让每一颗芯片,在离开工厂之前,就已经是一颗值得信赖的“好芯片”。 关于忱芯科技UniSiC 忱芯科技(UniSiC)是功率半导体自动化测试系统解决方案创新领导者,产品可覆盖SiC、GaN以及Si基功率半导体器件各测试环节,为功率半导体IDM企业、新能源车厂及Tier1、功率器件设计与封装企业提供精准、可靠、高性价比的测试解决方案。 忱芯科技的SiC功率半导体测试系统产品包括:晶圆级动态WLR测试系统、芯片级KGD测试系统、高温正偏测试系统、动态测试系统、静态测试系统、动态可靠性测试系统、连续功率测试系统等,全面覆盖功率半导体晶圆级测试、芯片级测试、单管/模块级测试和系统级测试,可满足实验室与生产线的多种场景需求。 |





