芯片设计一直都是很难的事情,特别是高性能芯片。芯片性能的提升,目前主要微架构的优化设计和依赖于制造工艺的快速迭代。“摩尔定律”(Moore)发展趋缓,依靠传统方法提升芯片算力的难度增加。由于愈发逼近物理极限,工艺研发难度不断加大,坚持攻克先进制程的fab厂仅剩寥寥几个;先进制程下高昂的芯片研发、制造费用也给fabless公司制造了巨大的成本压力与投资风险。这迫使人们寻求性价比更高的技术路线来满足产业界日益增长的对芯片性能的需求,芯粒(Chiplet)技术所代表的“超越摩尔”(More than Moore)方案就是其中的有力候选者。| Chiplet是什么? Chiplet是一种全新的芯片设计理念。为了便于理解,咱们先来看看目前的芯片是怎么设计出来的。大家会经常听到SoC这样一个芯片代名词。它是把很多的功能模块,比如CPU、存储器、接口这些通通集成在一个芯片上,做成一个大芯片。而Chiplet呢,与SoC反其道而行之,字面上翻译叫做“芯粒”,可以理解为小芯片的意思。在Chiplet设计理念下,是将原本SoC中的每个功能模块都单独拆出来,做成具有单独功能的一个个小芯片单元。 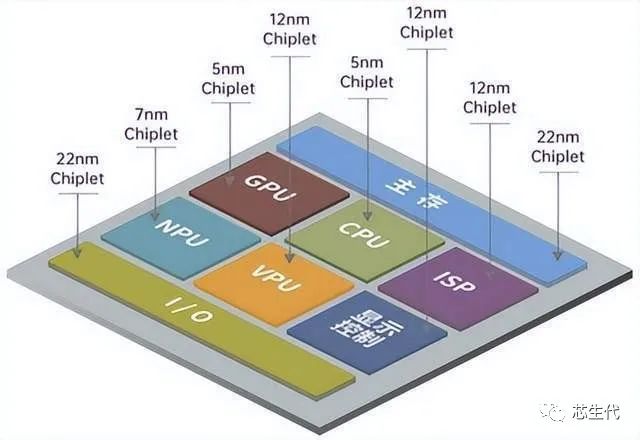 之后,通过先进封装技术,像搭积木一样,把这些小芯片再集成为一个系统级芯片。  | Chiplet、 SoC、SiP的区别 SoC(system on chip)叫做片上系统。是围绕CPU,将各种功能模块都集成在一颗芯片上的产物。  而Chiplet则不同,是先将各个功能模块做成小芯片,之后再封装到一起,组成系统级芯片。 表面上看,似乎只是制造工序的区别,其实Chiplet与SoC本质的不同是“异构异质”。异构集成,指的是可以将不同工艺的芯片集成到一起。 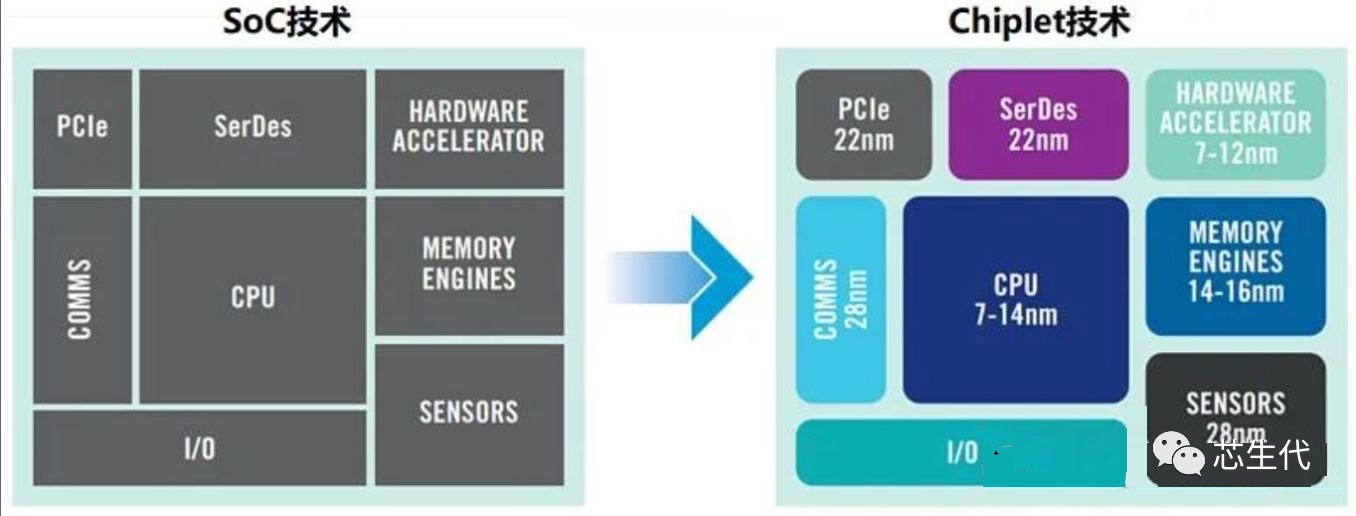 在SoC中,由于是在一个芯片中进行集成的,所以各个功能模块必须采用同一工艺制程,要是14nm的都是14nm的,要是7nm的都得是7nm的。而在Chiplet模式下,不同工艺的芯片可以凑到一起。比如CPU用7nm的,接口芯片用14nm的。这就是异构的概念。 异质集成,是指不同材料的芯片可以集成为一体。SoC肯定是办不到的。而Chiplet模式下,可以将Si、GaN、InP等等不同材质的小芯片集成到一起。 SiP(system in package)指系统级封装。通过将多种功能的芯片,包括处理器、存储器、FPGA等功能芯片集成在一个封装内,从而实现一个完整的系统。 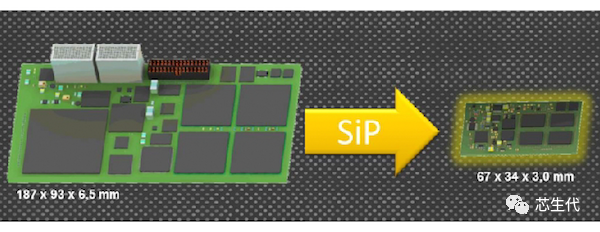 在概念上来讲,SiP与Chiplet很像。并且SiP同样能够实现异构异质集成的。而它们两者的区别在于,SiP是将不同芯片封装在一个基板上,Chiplet则是封装到芯片上。 因此,Chiplet还是属于芯片,而SiP只能算作小系统。Chiplet能达到SoC的性能 而SiP则不一样,因此Chiplet多用于高性能领域,SiP多用于小型化消费级产品。 | Chiplet的价值 可能有人会说,相比SoC,Chiplet工序既繁琐、又无法完全超越SoC的性能。但Chiplet确实存在它的意义: 1. 提高良率:大幅度提升良品率 芯片的良品率与芯片面积有关,芯粒技术设计将大芯片分成小模块可以有效改善良品率,降低因不良率导致的成本增加。 在芯片制造过程中,一片晶圆有固定的缺陷率。遇到这些无法修复的坏点,只能把它剔除掉。在同样缺陷分布的情况,切割裸片的的尺寸越大,缺陷的影响率就越高。  单颗SoC芯片的尺寸会随着集成规模的扩大而越来越大。当一颗芯片的尺寸达到400甚至600平方毫米时,芯片的良率就会变得很低。这时采用Chiplet模式,将大芯片拆成一个个小芯片,其芯片的良率将会提高。 2. 芯粒复用:降低设计的复杂度和设计成本芯粒技术通过在芯片设计阶段就将Soc(系统级晶片)按照不同功能模块分解成可重复运用的小芯粒,是一种新形式的IP复用,可大幅度降低设计复杂度和成本累次增加。在系统级芯片上,很多功能模块都是标准化的。那么在Chiplet模式下,应用厂商就可以生产出很多标准化的芯粒,下游客户直接购买芯粒进行封装就可以了。这就相当于芯粒的重复使用,无形中降低了开发难度,提升了效率。 此外,Chiplet模式具有异构集成的特点。有时候一颗高性能芯片,只需要CPU满足更高制程,其他芯片制程低一些没关系。在SoC中,所有功能模块都得跟着最高制程走。而在Chiplet模式下就可以区别配置。由于SoC上所有功能模块需同步迭代,伴随制程提高,芯片设计成本随之大幅增长。在工艺节点为 28nm 时,单颗芯片设计成本约为 0.41 亿美元,而工艺节点为 7nm 时,设计成本快速提升至 2.22 亿美元。  Chiplet模式下,芯粒可以选择性迭代,这种复用的结果会明显节约设计成本、缩短研发周期。 1. 落后制程弯道超车: 目前Chiplet具有两个设计思路:一是按照功能将不同模块拆分,比如AMD的三代锐龙处理器。  二是把具备完整功能的小芯片集合起来(俗称“芯片堆叠"),目的是实现性能的增长。比如苹果的M1 Ultra芯片,就是堆叠了两颗M1 Max芯片,从而获得两倍算力。 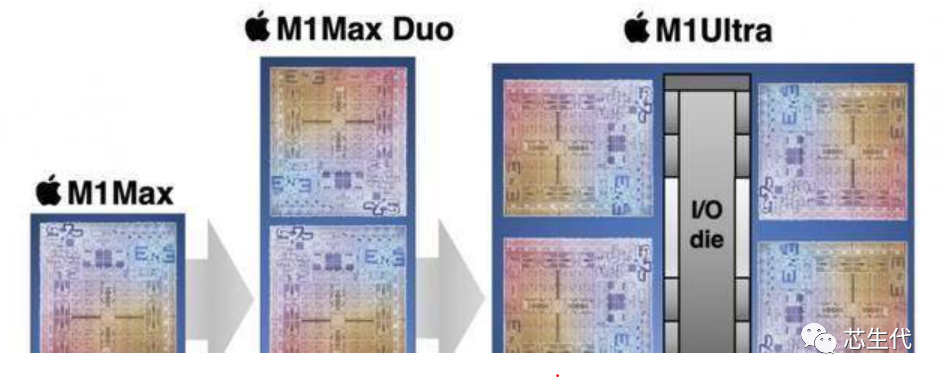 理论上可以通过Chiplet的堆叠,让低端产品实现高端产品的性能。 目前A国对中国高端制程芯片的封锁很严密,于是大家就考虑采用Chiplet技术,拿14nm、28nm的芯片堆叠出7nm、5nm的理想化的效果,实际上是做不到的,只能得到“1+1<2”结果。 所以这也是Chiplet概念近期炒作的逻辑之一。 | Chiplet与封装 Chiplet只能说是一种芯片的设计理念,真的要把一个个芯粒拼装在一起,关键得看封装技术能不能跟得上。 2.5D和3D先进封装,是配合Chiplet的工艺手段。 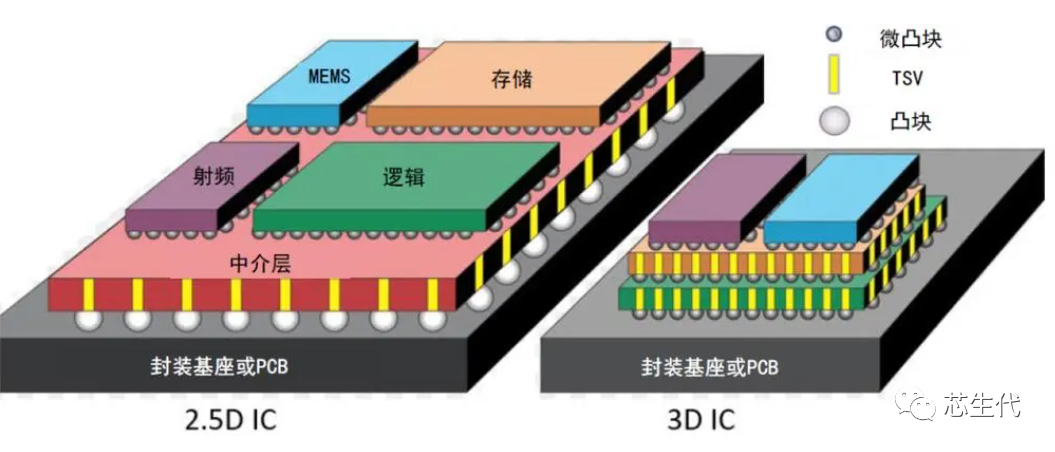 2.5D封装,是目前应用于Chiplet模式的主流方案,整体技术相对比较成熟。 什么是2.5D封装?说白了就是把一个个芯粒并列排布封装在一起。 不同芯粒之间如何实现互联互通,需要在下层PCB板与上层芯粒间,加入一片硅中介板(Silicon Interposer)。 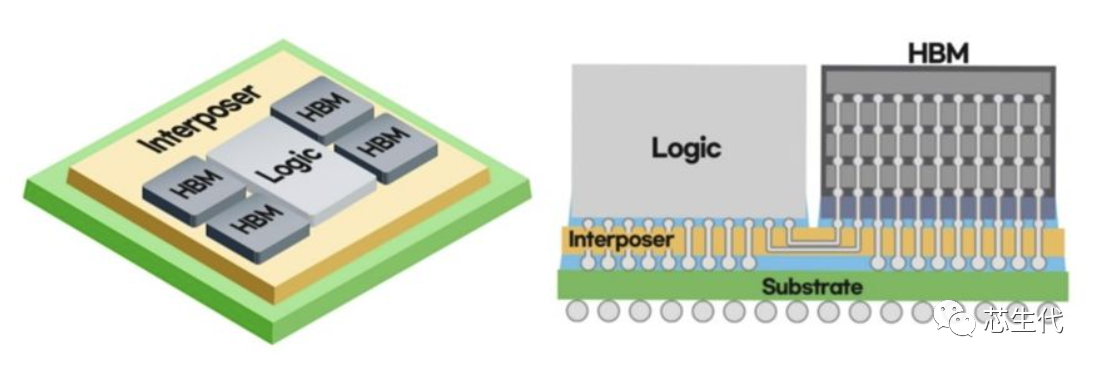 硅中介板本身没什么特别的,类似于一颗没有功能的晶圆。但难点在于,要在Interposer内部做很多硅通孔(TSV),起到电气垂直互联的作用。 这个工艺难度还是不小的。目前2.5D封装代表技术有三种,分别是台积电的CoWoS、英特尔的EMIB以及三星的I-Cube。 3D封装相比2.5D能够实现更高密度的堆叠。相比2.5D,小芯片可以直接摞在一起,这就需要在小芯片内直接制作硅通孔(TSV)。因此难度更大。  目前3D封装技术还不是很成熟。比较完善的是应用在DRAM领域,可以实现100多层的上下堆叠,但这都是同质范畴的,异质堆叠还没那么快。 3D封装技术目前主要有台积电的SoIC、英特尔的Foveros、三星的X-Cube。它们有晶圆制造能力,利用卡位优势,开发自己的先进封装技术。 当然传统封测厂同样也没闲着,在2.5D/3D封装技术上都有布局。比如国内通富微电、长电科技等等。 因此,Chiplet理想很丰满,但需要依托封装技术才能实现。 | 冷静看待Chiplet芯粒技术 随着摩尔定律走到极限,芯粒技术被行业普遍认为是未来5年算力的主要提升技术。华为、AMD、英特尔等行业巨头都积极布局芯粒并推出相关产品,2022年3月英特尔等多家巨头联合推出通用芯粒互联标准UCle;12月,首个中国小芯片标准发布。可以说,芯粒技术是国内外都看好的一条芯片新赛道。对中国而言,产业中短期内无法破解EUV光刻机卡脖子瓶颈,实现7nm以下工艺难度大,因此芯粒技术或将被寄予厚望,成为我国突破半导体工艺被卡脖子的重要途径。虽然如此,芯粒技术的未来发展仍需理性看待。 芯粒技术是先进制造工艺的补充,而不是颠覆式的替代。芯粒领域有很多技术挑战,还要满足不同应用场景的不同技术诉求,不会只停留在成熟工艺区间。这意味着我国科研人员依然要攻坚克难,加快多学科协同的技术攻关。 |





