芯片开封是集成电路失效分析(FA)和反向工程中至关重要的一步,其目的是在不损坏内部芯片结构的前提下,完整地移除包裹芯片的环氧树脂塑料(或其他材料)封装体,暴露出内部的晶粒(Die)、邦定线(Bond Wires)和焊盘(Pads),以便进行后续的显微镜检查、电性测试或探针探测。根据封装材料和开封原理,主要分为两大类: 1. 机械开封 (Mechanical Decapsulation):适用于陶瓷、金属封装。 2. 化学开封 (Chemical Decapsulation):适用于绝大多数塑料封装(环氧树脂),这是最主流的方法。 本文将重点介绍最常用的化学开封法。 化学开封的核心是使用发烟硝酸(Fuming Nitric Acid, HNO₃)或发烟硫酸(Fuming Sulfuric Acid, H₂SO₄)等强酸,通过加热或化学反应,选择性地溶解塑料封装料,而不会腐蚀内部的硅晶粒、金属线和焊盘。 前期准备 (Preparation)1. 安全第一 (Safety First):2. 个人防护装备 (PPE):必须在通风橱(Fume Hood)内进行操作。操作人员必须佩戴防酸面罩、防酸手套、防酸围裙和护目镜。 图1 通风厨 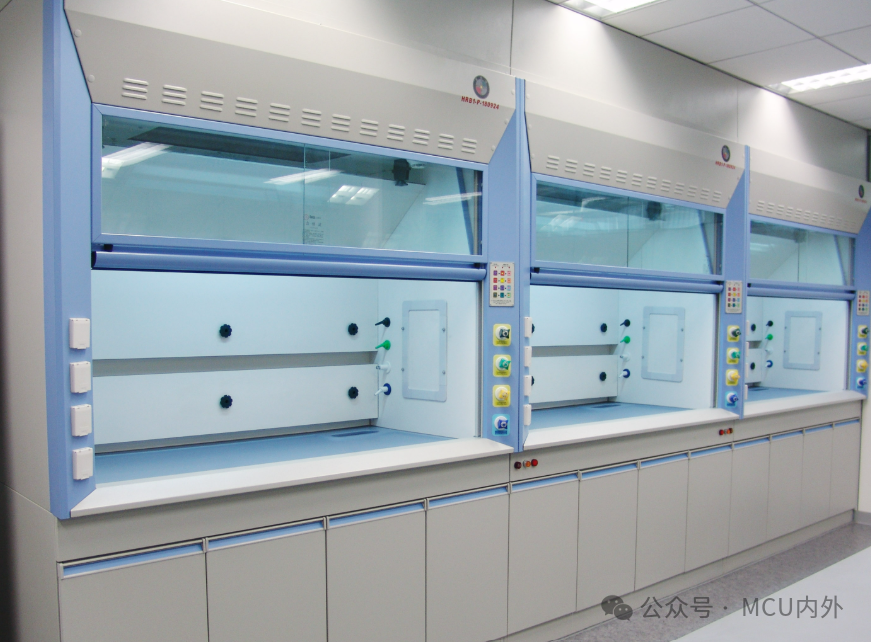 应急设备:附近应备有紧急洗眼器和冲淋装置。准备好酸液泄漏应急处理包(如中和剂)。 样品信息确认: 确认芯片的型号、封装类型(如QFP, BGA, SOP, DIP等)。 通过X-Ray透视检查芯片内部结构,初步判断晶粒位置、邦定线布局、是否存在空腔等,以确定最佳开封位置和方案。 样品预处理 (Sample Preparation): 去除引脚/焊球:对于BGA封装,可能需要先用热风枪或回流焊炉去除焊球。 表面清洁:使用异丙醇(IPA)等溶剂清洁芯片表面,去除污染物。 夹持固定:将芯片牢固地固定在特制的夹具(如陶瓷或Teflon夹具)上,确保只有需要开封的顶部暴露出来,侧面和底部被保护,防止酸液侵蚀引脚。 开封执行 (Decapsulation Process)方法A:滴酸法 (Acid Dropping Method) - 最常用设备与试剂: 专用开封机(Decapsulation Machine):通常包含一个加热台、一个精密滴酸泵、一个抽风系统和显微镜。 试剂:发烟硝酸(>90%浓度)或发烟硫酸。硝酸最常用,对环氧树脂溶解效率高;硫酸适用于一些特殊的耐硝酸封装料。 图2 化学开封机 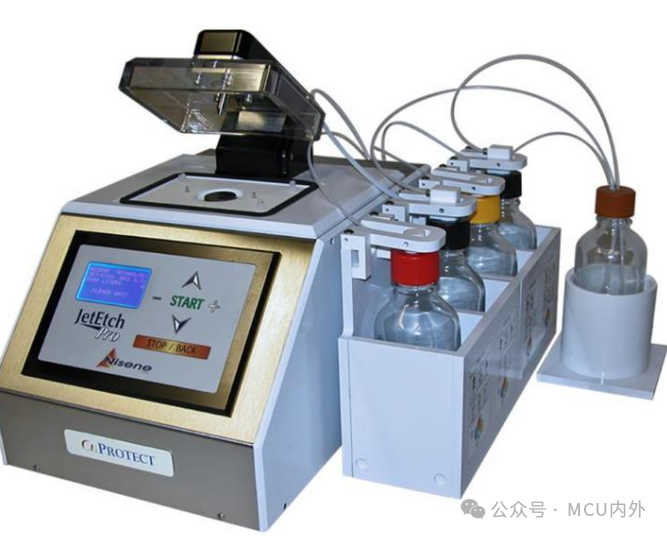 步骤: · 定位 (Positioning):将固定好的芯片放在加热台上。在显微镜下精确调整芯片位置,使滴酸针头对准需要开封的区域(通常是晶粒正上方的中心位置)。 · 加热 (Heating):开启加热台,通常设置温度在 60°C ~ 80°C 之间。加热可以显著加速酸与塑料的化学反应速度。 · 滴酸 (Acid Dropping): o 启动滴酸泵,将酸液以一滴一滴的方式滴加到芯片表面。 o 酸液会立即与塑料发生反应,产生气泡(反应副产物),并逐渐蚀刻出一个小坑。 · 观察与监控 (Monitoring):这是最关键的一步。通过显微镜实时观察腐蚀进程。 o 一旦看到金色的邦定线或银色的晶粒表面露出,必须立即停止滴酸。 o 如果酸滴在一个位置腐蚀太快,可以轻微移动芯片或针头,让酸液腐蚀其他还未暴露的区域,确保整个晶粒区域被均匀暴露。 · 终止反应 (Reaction Termination): o 停止滴酸后,立即用大量的去离子水(DI Water) 冲洗芯片表面,彻底中和并清除残留的酸液。 o 为防止残余酸液继续缓慢反应,通常会将芯片放入盛有酒精或丙酮的烧杯中,置于超声波清洗机中清洗几分钟,确保彻底清洁。 方法B:喷射法 (Jet-Etching Method) 使用更精密的设备,将酸液以高速、微小的喷射流形式冲击到芯片表面特定点。这种方法定位更精确,腐蚀速度更快,适合更小尺寸、更高精密的封装(如UCSP, WLCSP)。流程与滴酸法类似,但自动化程度更高。 后期处理与检查 (Post-processing & Inspection)1. 清洗与干燥 (Cleaning & Drying):o 经过超声波清洗后,用氮气枪(N₂ Gun)轻轻吹干芯片表面,避免水渍残留。 2 显微镜检查 (Microscopy Inspection): o 在光学显微镜或电子显微镜(SEM) 下仔细观察暴露出的晶粒和邦定线。 o 检查内容:邦定线是否完整、有无塌陷、断裂、熔融;晶粒表面有无划伤、坑洞、变色、烧毁点;焊盘是否腐蚀;有无外来污染物等。 3 存档 (Documentation): o 对开封后的芯片进行高分辨率拍照存档,记录所有观察到的现象,为后续分析提供依据。 图3 芯片开封 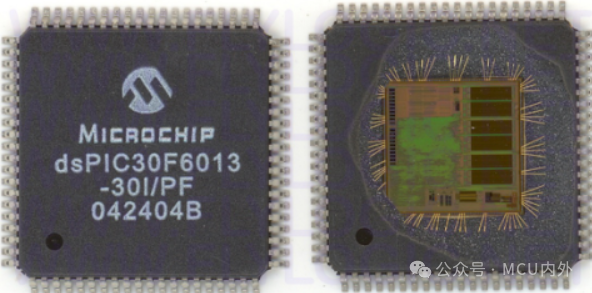 关键注意事项:终点判断 (Endpoint Detection):过度腐蚀会彻底损坏邦定线和晶粒上的铝层,导致分析失败。经验至关重要。 酸液选择:对于带有“软胶”(硅胶)保护层的芯片,需要先用硫酸腐蚀掉软胶,再用硝酸腐蚀硬胶,这是一个两步过程。 · 环境控制:整个过程必须在通风良好的通风橱内进行,防止酸雾危害健康和设备。 · 废物处理:使用过的酸液和清洗废液必须作为危险化学废液收集,并交由有资质的机构处理,不得直接倒入下水道。 机械开封:对于陶瓷或金属封装,无法用化学方法打开,通常采用:划片开槽:用精密的金刚石划片机或铣床在封装盖上切割出一个凹槽。 揭盖:然后用刀片或楔子小心地将切下的部分撬开。 总结:芯片开封是一项结合了化学、机械和光学技术的精密操作,需要专业的设备、丰富的经验和极度的谨慎。其核心流程可以概括为:安全准备 → 样品固定 → 加热与精准滴酸 → 实时显微镜监控 → 迅速终止反应与清洗 → 最终检查分析。成功的开封是后续一系列高级失效分析和反向工程工作的基础。 |





