不同底部填充(Underfill)技术自underfill在工业生产中广泛应用以来,已经发展出几种典型的underfill,包括毛细流动型底部填充胶(Capillary Underfill,CUF)、非流动型底部填充胶(No-Flow Underfill,NUF)、晶圆级底部填充胶(Wafer-Level Underfill, WLUF)及模塑底部填充胶(Molded Underfill,MUF)。 每种underfill材料在应用上都各有其优缺点,所以在填充过程中要需要根据产品的特点和性能要求选用合适的underfill及相应的填充工艺。 1.毛细流动型底部填充胶(CUF) CUF是最早出现的一类underfill,它是利用毛细作用流动填充芯片与底板间隙的一种低黏度填充胶。 CUF在FC封装回流焊接后进行填充固化,完整的工艺过程包括:助焊剂涂覆→芯片放置→加热回流→助焊剂清理→流动填充→加热固化,如图所示: 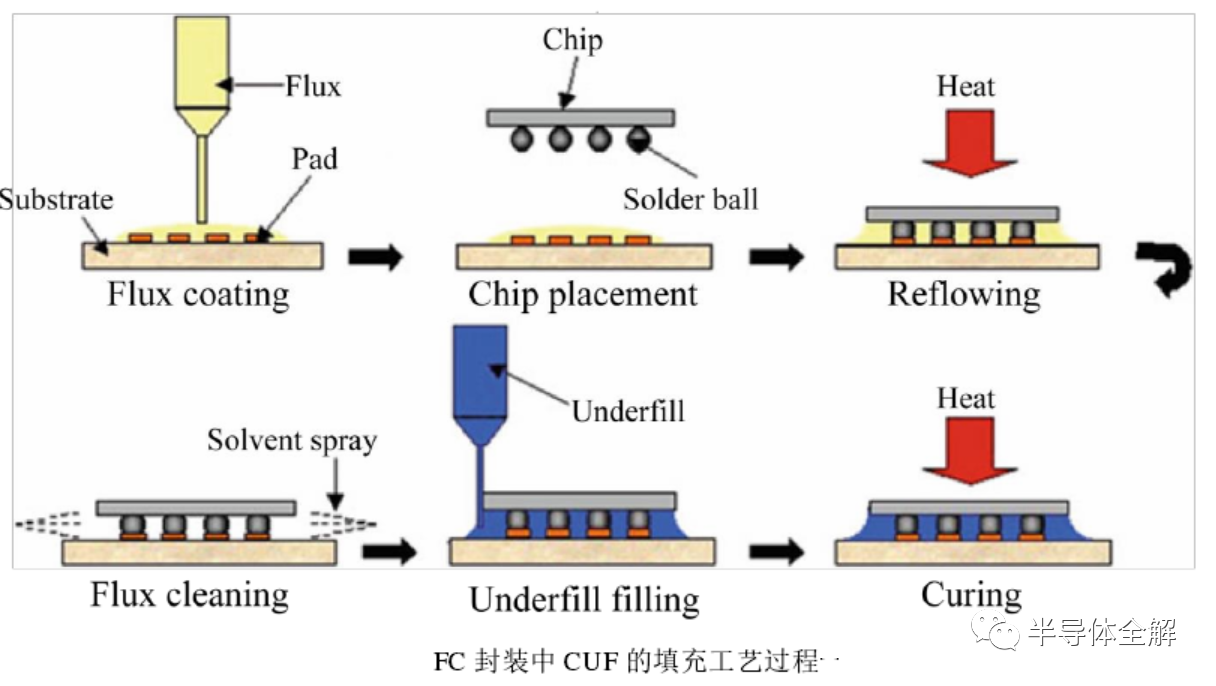 CUF是最早应用于电子封装的一种underfill。目前仍占据市场主流,应用范围很广,几乎面向各个层次的封装,如FC、CSP、BGA封装。但由于使用CUF时,工艺上多出了流动填充和加热固化的步骤,因而生产效率不高,另外毛细流动通常较慢且不够充分,从而导致固化后的underfill基体中出现空洞,还会出现填料在树脂体系中分布不均的现象,随着芯片尺寸的增大及焊点尺寸的减小,这种现象愈发严重。 2.非流动型底部填充胶(NUF) NUF是基于摩托罗拉(Motorola)公司于1992年发展的助焊剂和底部填充胶集成专利技术(Integrated flux and underfill)启发而发展起来,NUF填充固化工艺比CUF要简单,主要包括:underfill涂覆→芯片放置→回流焊接和固化,如图所示:  与CUF相比,NUF工艺步骤减少,生产效率高。 实现NUF这种新填充工艺的两个关键要素在于:潜性固化能力和固有助焊能力。NUF工艺的特性需要underfill有足够的反应潜伏期来保持低粘度,直至形成互连焊点。 由于NUF的固化和互连焊点的形成是在一个工序里完成,因此助焊剂是NUF中必不可少的成分。使用助焊剂是为了在回流过程中去除材料表面的氧化物,提高焊料的润湿性;同时,助焊剂在回流阶段应避免产生挥发性物质,保证填充稳定性。 NUF几乎可用于所有封装层次,由于NUF将传统underfill底部填充工艺上的流动填充、助焊剂涂覆清理、焊料回流、underfill固化简化成一个工艺步骤,大大提高了生产效率;但由于NUF填料少、热膨胀系数比较高,固化物常有气泡和空洞等问题,其尚未成为市场主流产品。 3.晶圆级底部填充胶(WLUF) 由于NUF工艺需要先在基板上涂敷underfill,这与表面贴装技术(Surface Mounted Technology, SMT)并不完全兼容。针对此问题后来发展出了与SMT兼容的WLUF工艺,该工艺以其低成本、高可靠性而获得了成功应用。 WLUF工艺首先在有凸点或无凸点的晶圆片上采用印制或涂敷添加一层underfill,然后进行部分固化。对于尚未制作凸点的晶圆,则需在划片前制作凸点,然后再进行划片。每单个芯片均可以通过标准的SMT工艺实现与基板的互连,工艺流程如图所示。 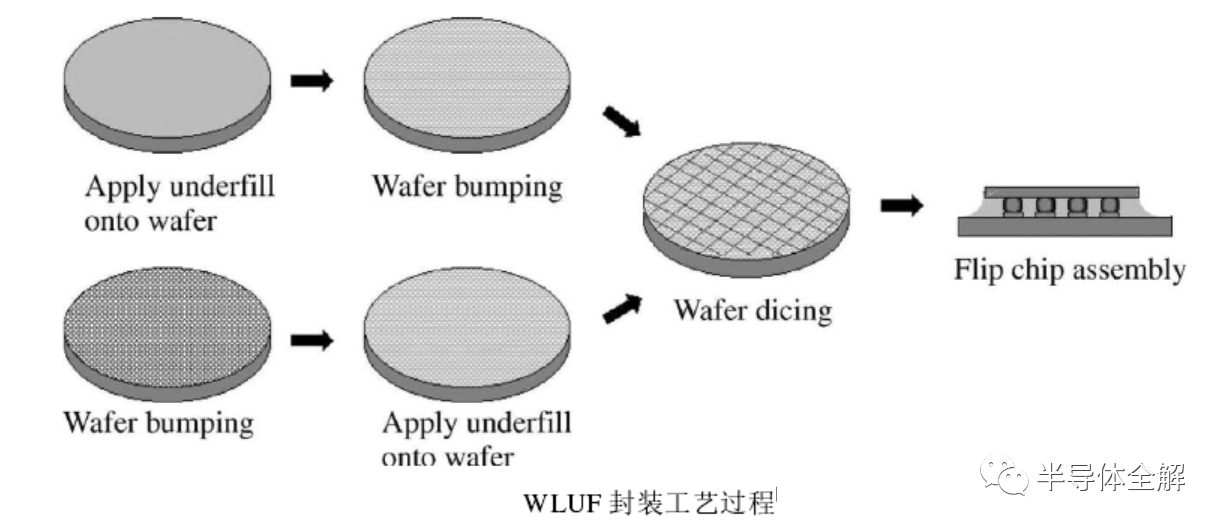 与NUF相同,WLUF也要求含有适当的助焊剂,填料含量很少甚至没有,以达到100%的焊点连通率。此外,WLUF固化物需要一定的透明度以防晶圆的切割线模糊不清;WLUF需要良好的激光可加工性,便于划片切割和打孔;此外,WLUF需要有低的介电常数和热膨胀系数来更好地实现应力均匀分布。 由于WLUF在芯片放置之前就已经将部分固化的WLUF预涂覆在裸芯片上,完全适用于标准FC设备,大大提高了生产效率。但由于几乎不含填料,还需要解决WLUF热疲劳稳定性问题。由于工艺过程的限制,WLUF只适用于FC封装。 4.模塑底部填充胶(MUF) MUF是可以向模具直接注入,将包括芯片和底板间隙的整个器件进行封装保护的一种underfill材料。MUF直接将底部填充和二次成型(Over molding)封装在一个工艺步骤里完成,可降低成本,大大提高生产效率。MUF不仅填充芯片与基板之间的间隙,同时还包覆整个芯片并提高了器件力学稳定性。 MUF特别适用于倒装芯片封装,能够提高生产效率。据报道,MUF工艺可将传统底部填充工艺的生产效率提高4倍。 MUF工艺在模具设计和工艺方面与增压底部填充类似,只是前者采用的不是只填充芯片与基板间隙的液态密封剂,而是包封整个器件的模塑化合物。 下图所示为CUF与MUF工艺过程对比以及常见的FC-BGA封装采用MFU工艺的模具设计。 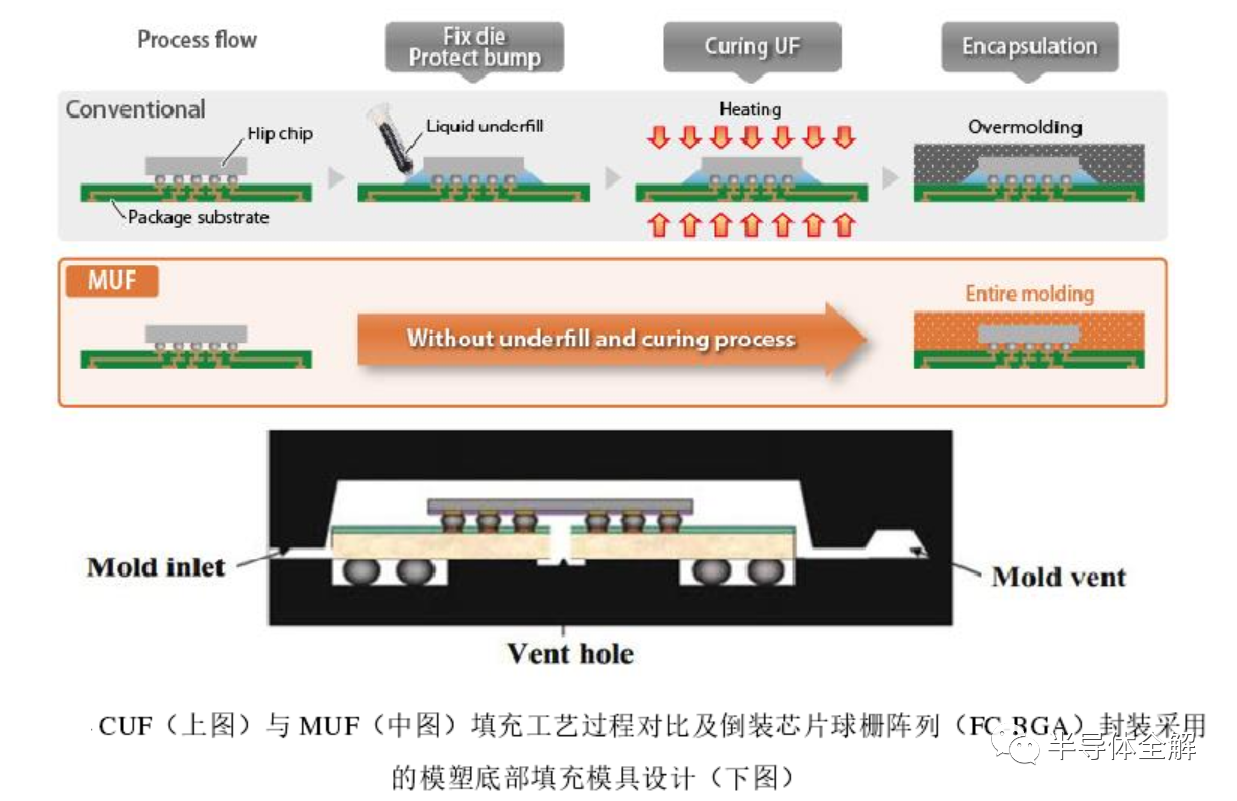 MUF封装技术将注塑工艺和underfill相结合,可大大提高生产效率,降低生产成本,同时可显著提高封装器件的可靠性; MUF可以对许多小的间隙进行填充,特别是小芯片微小间距时,填充效果好,有利于电子产品微型化和多功能化;MUF模具填充最小间隙高度可达40um;但MUF的可返修性差。MUF一般适合FC、CSP层次的单个或多个芯片的封装。 |





