|
集成电路(IC)在电子学金字塔中的位置既是金字塔的尖顶又是金字塔的基座。说它同时处在这两种位置都有很充分的根据。从电子元器件(如晶体管)的密度这个角度上来说,IC代表了电子学的尖端。但是IC又是一个起始点,是一种基本结构单元,是组成我们生活中大多数电子系统的基础。同样,IC不仅仅是单块芯片或者基本电子结构,IC的种类千差万别(模拟电路、数字电路、射频电路、传感器等),因而对于封装的需求和要求也各不相同。本文对IC封装技术做了全面的回顾,以粗线条的方式介绍了制造这些不可缺少的封装结构时用到的各种材料和工艺。
虽然IC的物理结构、应用领域、I/O数量差异很大,但是IC封装的作用和功能却差别不大,封装的目的也相当的一致。作为“芯片的保护者”,封装起到了好几个作用,归纳起来主要有两个根本的功能:1)保护芯片,使其免受物理损伤;2)重新分布I/O,获得更易于在装配中处理的引脚节距。封装还有其他一些次要的作用,比如提供一种更易于标准化的结构,为芯片提供散热通路,使芯片避免产生α粒子造成的软错误,以及提供一种更方便于测试和老化试验的结构。封装还能用于多个IC的互连。可以使用引线键合技术等标准的互连技术来直接进行互连。或者也可用封装提供的互连通路,如混合封装技术、多芯片组件(MCM)、系统级封装(SiP)以及更广泛的系统体积小型化和互连(VSMI)概念所包含的其他方法中使用的互连通路,来间接地进行互连。
随着微电子机械系统(MEMS)器件和片上实验室(lab-on-chip)器件的不断发展,封装起到了更多的作用:如限制芯片与外界的接触、满足压差的要求以及满足化学和大气环境的要求。人们还日益关注并积极投身于光电子封装的研究,以满足这一重要领域不断发展的要求。最近几年人们对IC封装的重要性和不断增加的功能的看法发生了很大的转变,IC封装已经成为了和IC本身一样重要的一个领域。这是因为在很多情况下,IC的性能受到IC封装的制约,因此,人们越来越注重发展IC封装技术以迎接新的挑战。
IC封装家族
虽然有很多方法对IC封装进行分类,但是IC封装主要可以通过其基本结构的不同进行分类和定义。根据这一标准,IC封装的两个主要类别是引线框架式封装和基板式封装。还可以将后者进一步细分为有机层压基板材料和陶瓷基板材料。现在还出现了一种封装类型,它着眼于在圆片上进行封装,被称作为圆片级封装(WLP)。封装在圆片的表面进行,这样就能制成真正意义上的芯片尺寸封装。
在定义了封装的基本结构之后,继续介绍下一级互连中的封装技术。比如,以引线框架和双列直插封装(DIP)为代表的许多传统IC封装,用于针脚插入型焊接装配。而以针栅阵列(PGA)为代表的其他形式的封装可插在插孔中。还有一些,如以四方扁平封装(QFP)、无引脚引线框架封装和面积接近芯片面积的四方扁平无引脚封装(QFN)为代表的柔性引脚引线框架封装,则用于表面贴装技术(图1)。
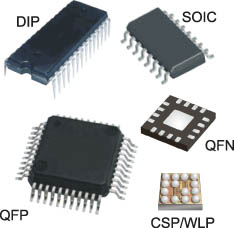
图1. IC封装有着许多种尺寸、形状和引脚数量,以满足IC和系统不同的要求。
除了以QFP和QFN为代表的四周引脚封装,还有平面阵列封装。由于平面阵列封装本身具有良好的处理高I/O数和管理I/O端分布的能力,而同时又不会降低性能,所以用平面阵列的方法来形成IC封装的I/O已经变得越来越普及。球栅阵列封装(BGA)就是平面阵列封装的典型代表。正是由于这些优势,BGA的身影出现在了从微小尺寸芯片、圆片级封装到拥有数千个I/O的大尺寸IC的各个应用领域。由于已经有了制造有机层压基板的划算的大型制造设备,所以BGA封装通常采用这种基板。BGA封装还经常被用于不断成长的叠层芯片、多芯片和叠层封装结构之中。多芯片封装被认为是一种有可能替代芯片上系统(SOC)的可行的解决方案。现在还日益涌现出基于阶梯形封装和双面互连概念的新的封装形式(图2)。
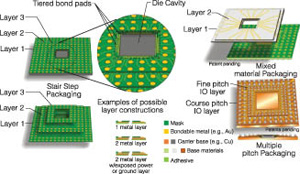
图2. 不同寻常的BGA封装结构的示意图(由SiliconPipe公司提供)。
IC封装材料和封装技术回顾
制造这些各种各样的IC封装时用到的材料十分重要。它们的物理性质、电学性质和化学性质构成了封装的基础,并会最终影响到封装性能的极限。引线框架封装和层压基板封装结构的物理性质有显而易见的差异;然而,相对于这两种封装各不相同的材料性质,人们对于封装性能要求却基本一致。进行一次对于封装组成要素逐点详述的回顾会有助于展现封装中选择的多样性和性能需求的复杂性。
按照合乎逻辑的次序,理应从引线框架材料开始讲起,这是因为使用引线框架的产品仍然在IC封装中占据主导地位。引线框架主要用于引线键合互连的芯片。能够焊接引线的表面处理层,如银或金,被镀在一个被称为“内部引线键合区”的区域上。这道工艺采用了局部镀膜方法。由于贵金属很难同塑封料结合,所以这道工艺成本较高。
用于IC封装中的引线框架的金属材料一般根据封装的要求在几种材料中选取一种。对于陶瓷封装,一般选择合金42或Iconel合金作为引线框架材料,因为这些合金与陶瓷材料基板的热膨胀系数(CTE)相匹配。因为陶瓷材料的脆性的缘故,CTE匹配对于陶瓷材料很重要。但是,在表面贴装元件的最后的装配中,根据尺寸的不同,低CTE材料会对可靠性产生负面影响。这是因为这些低CTE材料与大多数的标准的PCB基板的CTE产生失配。虽然高模量、低CTE的金属材料作为引线框架材料时,能够在陶瓷封装和塑料DIP封装中表现良好,但是在表面贴装塑料封装时,铜是一种更好的引线框架材料。因为铜更加柔软,能够更好地保护焊点。铜还具有电导率更高的优点。
由于产业界要面对日益迫近的欧洲新标准的挑战,因此对于下一级组装来说引脚表面处理技术显得日益重要。这一问题在过去几年之中已经成为了无数论文的主题。其重点是寻找一种长久以来一直使用着的且其性质已为人所熟悉的铅锡焊料的替代物。由于未来的供应商面临着激烈的市场竞争,所以并不会存在一个单一的解决方案。在未来的几年中,人们很有可能对到底采用何种材料作为引线表面处理材料会更加困惑。
芯片粘接材料的作用是将芯片固定在衬底之上。看上去是很简单的事情,但是对此的要求视应用领域的不同而各不相同。在大多数情况下,芯片粘接用于芯片面朝上的引线键合封装。这种材料要能够导热,在有些时候还要能够导电。为了避免在芯片上产生热积存,芯片粘接工艺应该保证在粘接材料中没有空洞。随着芯片功耗的不断提高,这一点会变得越加重要。
芯片粘接材料是液态材料或薄膜材料。它们被设计成不会脱气,因为任何脱气产物重新沉积在焊盘上都会降低引线键合的质量。芯片粘接材料的还起着应力缓冲层的作用,用以防止芯片由于与基板的CTE失配而产生断裂。如果选取的芯片粘接材料合适,就能够保证在芯片尺寸封装(CSP)中在芯片下面重新分布的I/O的可靠性。经过改良的芯片粘接材料还用于倒装焊互连中。在这种应用中,IC通常有凸点,而粘附层中分布有导电颗粒。这种类型的芯片粘接材料也被称作各向异性导电胶。
再回到引线键合封装。在引线键合技术中,主要有三种焊接技术:热压焊、热超声球焊和室温超声楔焊。但只有后两种焊接技术现在仍然在被广泛采用。在热超声焊中普遍采用金丝。铜丝是另外一种可用的材料,但是需要在富含氮气的环境下进行焊接。铝丝则常用在低成本的楔焊中。
层压基板材料可以替代引线框架用于IC封装。它经常出现在I/O数很多或者对性能要求很高的封装中。从上世纪70年代末开始,基板应用在板上芯片(chip-on-board)中。实际上,当仔细观察板上芯片时,你会清楚地发现它包含有封装的所有基本元素,可以说它根本上是“现场封装”。层压基板封装结构现在仍在使用中,并且是一种十分重要的IC封装手段。它可以作为厚膜陶瓷基板和薄膜陶瓷基板的一种低成本的替代品。新型的高温有机层压基板受到人们的青睐,不仅因为它们的成本很低,而且它们的电学性能也更加优越(如较低的介电常数)。
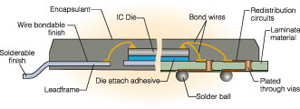
图3. 各种不同类型的封装有着一些共同的特点。封装的重点就是进行密封并将输入输出端重新安排成一个更加有用的结构。
塑封料是IC封装材料中的最后一个组成部分。引线框架主要重新分配了具有精细引脚节距的芯片I/O,而塑封料则具有另外的作用。它的主要作用就是保护芯片和脆弱的互连线免受物理损害和外界环境的不利影响。塑封料的使用一定要谨慎而精确,以免产生引线偏移(冲丝),从而造成引线间的短路。
IC封装中有三种主要的塑封料。第一种是环氧树脂和环氧树脂混合物。作为结构工程领域中常用的树脂材料,环氧树脂也是如今最为常见的一种有机树脂塑封料。环氧树脂具有良好的综合性能和热性能,而且成本相对较低。
硅树脂材料是IC封装中另一种常用的塑封料。尽管硅树脂的制造工艺和固化工艺同有机树脂的相似,但是由于硅树脂是含硅的,而不是含碳的,所以它们不能被称为是有机树脂。硅树脂有两个主要的种类:溶剂型硅树脂和室温下可硫化的(RTV)硅树脂。按照硅树脂种类的不同,它们的固化机理也不相同。RTV可以通过暴露在潮湿的环境下(室内的湿度)或者加入催化剂来进行固化。相反,溶剂型硅树脂常通过加热使溶剂蒸发来进行固化。硅树脂在一定温度范围内(从-65℃到150℃)是柔性的,这就使得它在需要柔性材料的芯片尺寸封装(CSP)中受到青睐。
最后一种基本塑封料是聚酰亚胺。聚酰亚胺在IC封装中用作塑封料并不多见。它常用于芯片粘接之中。聚酰亚胺拥有的高温性能使其能够在高温环境中得到应用。
随着欧盟法规规定要采用一种新材料来替代传统的焊料,塑封料现在正面临着要与新焊料相匹配的问题。能够满足欧盟法律规定的高锡含量的焊料对高温有着严格的要求,这就导致了其对于湿度更高的敏感性。根据电子工程设计发展联合会议(JEDEC)中对湿度敏感性的规定,现在大多数的材料在这个指标上低了两个等级。在封装时需要更长时间的预烘焙以除去湿气来防止爆米花开裂现象或残留湿气在回流时爆炸性地外泄。

表1 IC封装中使用的材料的列表。请注意各种基本类型的IC封装大都采用了同样的材料
结论
这篇回顾着重揭示了IC封装技术在电子产业中所发挥的重要作用,并论证了IC封装在电子系统设计领域中所处的无可辩驳的重要地位。随着I/O数量的增加和器件性能要求的不断提高,可供选择的封装类型也越来越多,为那些十分困难的问题提供了解决方案。但它也是对那些寻求单一标准的努力的一种诅咒。可以确切预见的是,总有一天标准会变得不再那么重要,尤其在IC、封装和基板一体化设计的概念变得普及之后更是如此。虽然客户定制化设计会变得更加常见,但是用于制造电子产业链中十分重要的具有纽带性质的封装产品的工艺和材料却会相对地保持稳定,只有那些能够创造巨大效益的研发才能被IC封装技术所接受。
作者:Joseph Fjelstad, SiliconPipe公司
|