"书接上文,今天继续来聊一聊存储类器件的功能测试。"首先,基于存储类器件(Memory)的功能测试,存在七种故障类型: [1] 存储单元固定故障(Cell Stuck Failure) 故障特征:存储单元数据被固定为"0"或"1",即使执行写入操作也无法改变其状态 [2] 存储单元间干扰故障(Interference Between Cells) 故障机制:当向特定存储单元(称为主单元/Pivot Cell)写入数据时,相邻或周边的存储单元会被意外写入相同值或其反相值  [3] 读出放大器操作故障(Sense Amplifier Operation Failure) 故障影响:当读出放大器工作异常时,与其相连的整条位线(bit line)上的所有存储单元均无法正常读写 故障机理: 灵敏度下降导致信号辨识失败 偏置电压异常造成放大功能失效 时序错误引发误判 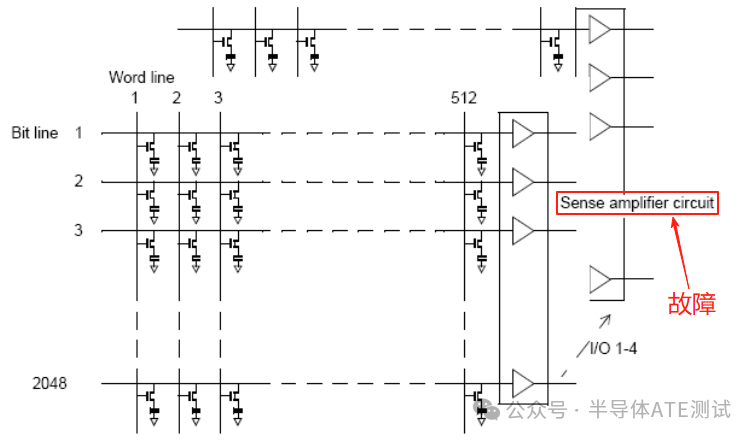 [4] 数据输入/输出电路故障 (Data Input/Output Circuit Failure) 故障影响:当数据输入/输出电路异常时,所有存储单元均无法正常进行数据读写操作 失效点: 数据缓冲器(Data Buffer)功能异常 DQ信号通道阻抗失配 读写控制逻辑错误 [5] 地址译码器故障 (Address Decoder Failure) 故障表现:单个存储单元对应多个物理地址(地址冲突), 单个地址指向多个存储单元(数据串扰) 成因: 译码逻辑电路失效, 行/列地址线短路 [6] 数据保持故障 (Data Retention Failure) 故障特征:存储单元无法在指定时间内保持写入数据(低于JEDEC标准规定的保持时间) 影响因素:存储电容漏电, 刷新周期异常, 工作温度超标等 [7] 擦除/写入故障(Erase/Write Failure, EEPROM/Flash特有) 故障机理: 浮栅电荷注入/释放失效, 隧道氧化层击穿 诊断工具: 采用失效位图(Fail Bit Map)分析技术 结合擦写循环次数(P/E Cycles)进行可靠性验证 虽然仅凭存储器功能测试结果难以精确定位故障根源,但借助失效位图(Fail Bit Map,简称FBM)分析技术,可有效判定故障成因。 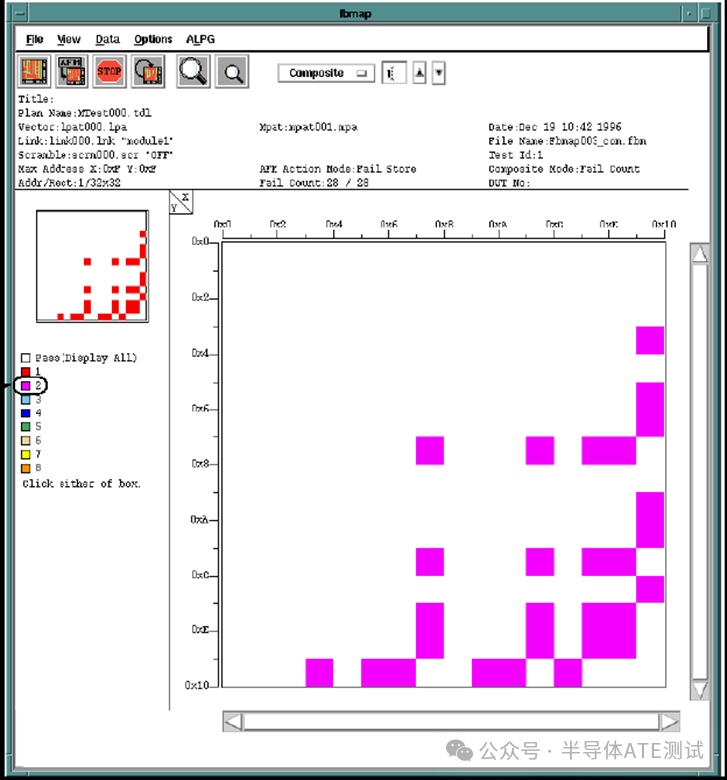 以下图片展示了失效存储单元分布模式与潜在故障原因的对应关系,x代表失效Bit分布: 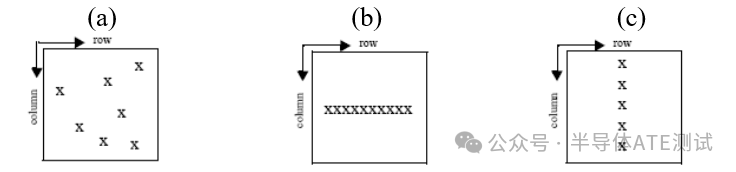 (a) 图所示FBM呈现不规则分布,可能故障类型为存储单元固定故障(Cell Stuck Failure), 失效原因:晶体管栅氧击穿, 接触孔通阻异常 亦可能是单元间干扰故障(Interference Between Cells)失效原因:耦合电容超标(> 5fF)相邻单元间距违反设计规则(Spacing < 0.7x最小节距) (b) 图所示FBM呈现沿特定列方向线性分布,可能故障类型为:读出放大器故障(Sense Amplifier Failure)空间分布特性: 严格沿位线(Bit Line)方向连续分布, 失效单元数量与位线长度正相关(如DDR4中每列512单元同时失效) (c) 图所示FBM呈现沿特定行方向线性分布,可能故障类型为:字线故障(WORD Line Failure)空间分布特性: 严格沿字线方向连续失效, 在3D NAND中可能表现为跨多存储层的垂直失效柱(Via Chain Failure) 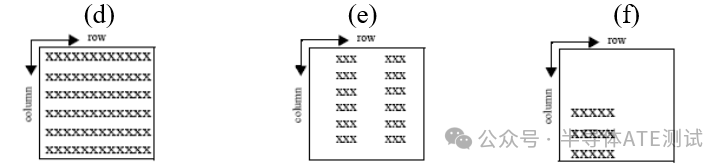 (d) 图所示FBM呈现全区域分布,可能故障类型为:数据输入/输出电路故障(Data Input/Output Circuit Failure)空间分布特性:失效单元均匀分布于所有存储阵列区域,与地址译码模式无相关性(区别于行/列故障) (e) 图所示FBM呈现带状分布的失效单元,可能故障类型为:地址译码器故障(Address Decoder Failure)空间分布特性:呈现带状或块状集群分布,与地址空间映射相关,在3D堆叠存储器中可能表现为跨多存储层的垂直失效带 (f) 图所示FBM呈现局部区域集中失效,可能故障类型为:地址译码器局部故障(Localized Address Decoder Failure)空间分布特性:失效单元集中出现在特定存储区块(如Bank2的A区),在3D NAND中可能表现为特定存储层的平面性失效 由于存储器存在多种故障类型,需采用多样化的测试模式进行检测。 Memory Test Pattern主要包括以下类型: 1. 基础测试模式(线性复杂度 O(N))0/1 写入读取测试(0/1 Write & Read) 用途:检测固定故障(Stuck-at Fault) 操作序列:全写0 → 全读0 → 全写1 → 全读1  棋盘格测试(Checkerboard) 用途:识别相邻单元干扰(Adjacent Cell Interference) 数据模式:交替写入"0x55"和"0xAA" 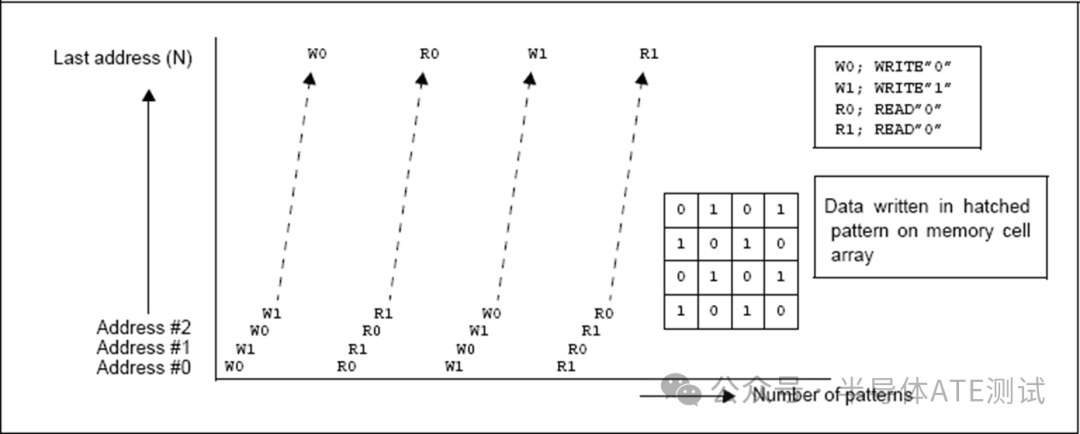 行进测试(Marching) 用途:覆盖地址译码故障(Address Decoder Fault) 典型算法:March C-(→写0 →读0 →写1 →读1 ←写0 ←读0 ←写1 ←读1) 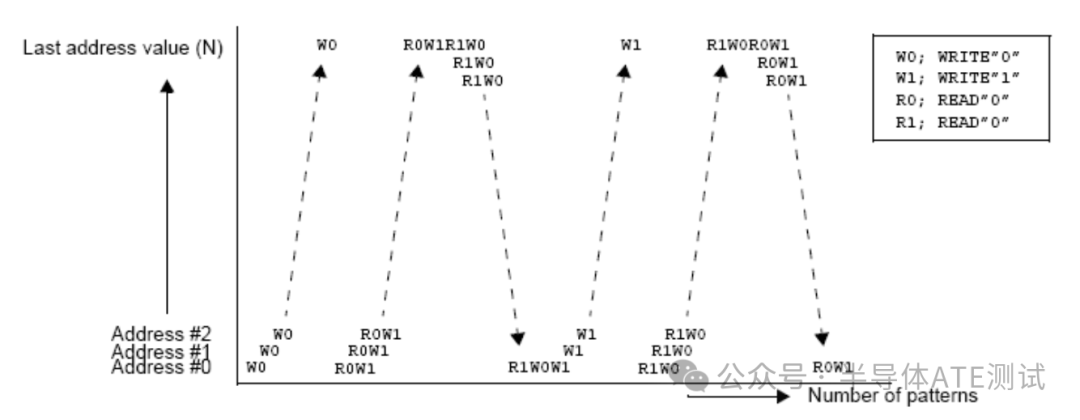 2. 高阶测试模式(非线性复杂度)蝶形测试(Butterfly, O(N^1.5)) 用途:检测动态耦合故障(Dynamic Coupling Fault) 特性:同时激活多行/多列,验证电荷共享效应  步进测试(Walking, O(N^2)) 用途:定位敏感单元(Weak Cell) 方法:逐位翻转数据并监测周围单元状态 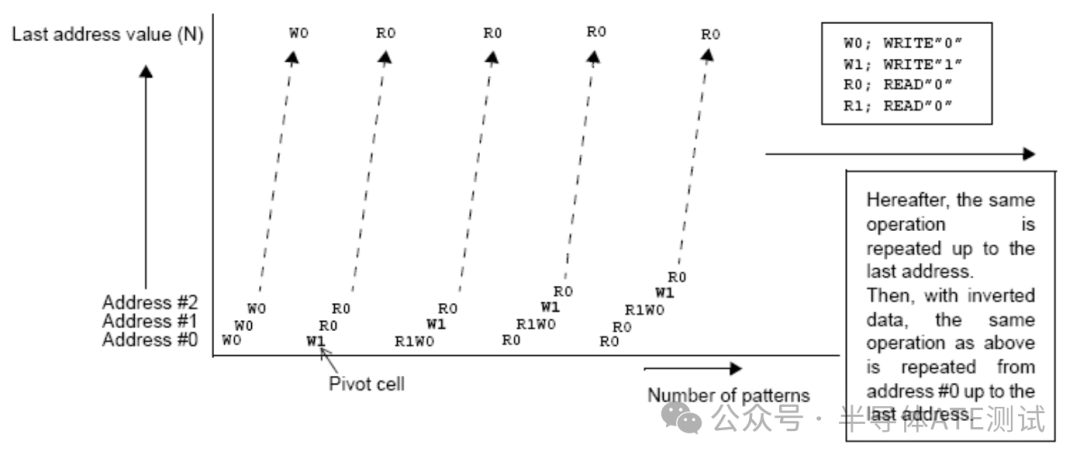 跃步测试(Galloping, O(N^2)) 用途:诊断读写恢复时间故障(tWR/tRCD Violation) 操作:快速交替读写目标单元与背景单元  |





