晶片测试(Wafer Test)晶片制造过程结束后,晶片上排列着无数个完整的LSI芯片,在这种状态下直接利用测试装置和晶片探针对每一个芯片进行测试。 对于存储器,同时还进行修复分析,利用预先设置于芯片内部的备用单元置换一定数量以内的不合格单元。 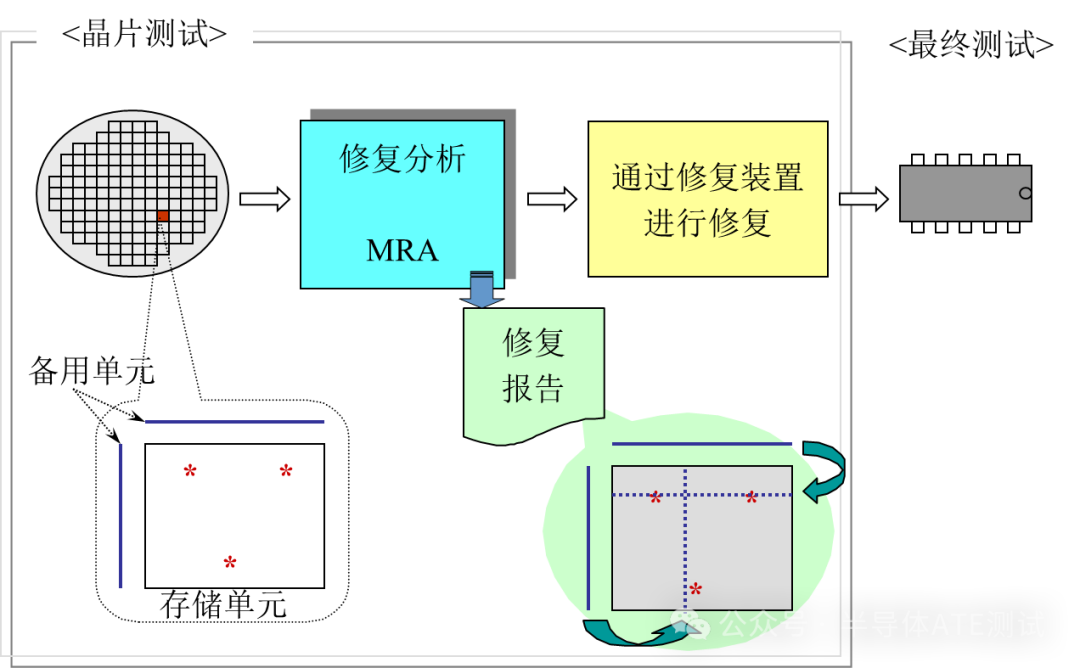 测试目的(Test Aim) · 在封装之前排除不合格品,以此消除不必要的封装成本 · 将不合格产品信息反馈给晶片制造过程,以此提升产品合格率 晶片测试中包括以下几种测试内容 · 接触测试:用探针接触元器件的引线,确认是否存在接触不良 · DC参数测试(直流试验) · 功能测试 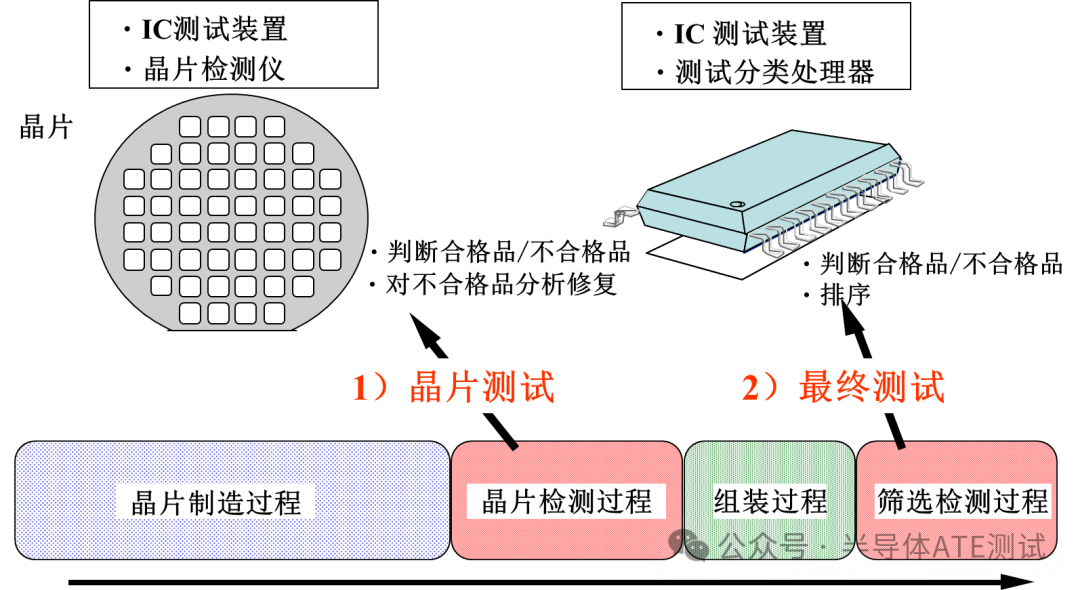 最终测试(Final Test) · 利用分类处理器和测试装置,对已封装产品的功能、性能、质量进行最终测试。 · 测试环境分低温、常温和高温,在不同温度环境中进行测试。 最终测试中包括如下几种测试内容 · 接触测试:确认已封装元器件的引线是否存在接触不良 · DC参数测试(直流试验) · 功能测试 · AC参数测试(交流特性):测试时间方面的特性 具体测试类型描述如下: 1)接触测试 利用测试装置,确认元器件引线(引脚)等是否接触良好 2)DC参数测试(直流试验) 对元器件的DC特性(电压、电流)进行测试,测试内容包括电源电流测定、输入电流特性及输出电压测定等,并且判断测定值是否符合规定值 3)功能测试(功能试验) 通过性能测试,确认IC的规定功能是否正常运行 · 测试运算是否正常进行 · 测试是否正常保存数据以及是否正常读取数据 4)AC参数测试(交流试验) 测试IC的交流特性(时间方面的特性) 通过测试,确认IC的各项功能是否超过规格中规定的速度运行 · 逻辑IC-测定演算结果得出的时间 · 存储IC-测定数据写入、读取的时间 测试方法 让元器件进行实际运行,检查其是否按照相关规格正常运行  该元器件的测试步骤如下: 1. 连接电源线、GND、信号输入线、信号输出线。 2. 外加电源电压。 3. 外加输入信号,这时注意观察输出信号,如果元器件正常完成右表所示的动作就视为OK,如果无法完成就视为NG。 |





