应市场要求,LED芯片功率不断增大,导致LED工作时结温升高,因此对产品的散热性能要求也越来越高。综合分析目前市场上LED灯的不同封装类型及研究现状后,本文基于Fluent有限体积方法对LED的SMD(表面贴片)封装和COB(板上芯片)封装进行散热分析。结果表明:3种不同结构的COB封装中,倒装COB封装散热效果最好,垂直结构COB封装次之,最后是正装COB封装,但无论哪种结构的COB封装,其散热效果均优于SMD封装。研究发现,随着基板尺寸的增大,3种结构COB封装的结温逐渐减小,但LED结温变化率也随基板尺寸增大而减小,散热效果提升不明显。引言 发光二极管(LightEmittingDiode,LED)作为光源由于寿命长,体积小,能耗低,发光效率高等优点,逐渐代替传统光源成为目前照明市场上的主流产品。凭借良好的性能、对环境的友好性,LED广泛应用于一般照明、道路照明、汽车照明、液晶显示屏等方面[1-4],也逐渐向生物、医疗等领域拓展,并取得了很大进展[5-7]。目前LED产品性能还有很大的提升空间,LED高结温对于LED各方面的性能有着巨大影响,具体表现在使用寿命、正向电压、发光波长、发光效率、荧光粉效率、光通量等方面[8-11]。 LED结温产生的内部因素有两个。一是内部量子效率不高,即电子和空穴复合时,不能全部产生光子,其中一部分转化为热能散失。二是外部量子效率不高,LED芯片内部产生的光子无法全部辐射到芯片外部而最后转化为热量,这是LED产生热量的主要原因。外界因素如增大环境温度和加大电流注入率[12]也会增大LED结温。LED结温升高,热量却不能及时散失将会影响LED性能,甚至可能导致LED芯片永久损坏,不能使用。因此LED散热问题引起了研究者的广泛关注。通过增加散热来降低LED结温从而提高LED安全性、可靠性以及各方面性能成为LED灯具研究必不可少的一项。 目前LED散热主要分为LED封装级散热、LED芯片级散热、LED系统级散热3种方式。 LED芯片的封装方式经历了插针式(DIP)、贴片式(SMD)和板上芯片式(COB)等封装结构[13]。关于COB封装散热的研究已经很充分,目前得到了广泛的应用[14]。文尚胜等[15]采用ANSYS有限元分析软件对同时采用COB技术和共晶焊工艺的大功率LED热特性进行了分析。结合二者可有效地提高大功率LED的散热性能。张剑平等[16]利用电压法测量并分析了金属铝基板和氧化铝陶瓷基板的大功率COBLED光源散热性能,在相同条件下,采用金属铝基板的COBLED光源热阻更小,散热性能更优。 LED芯片产生的热量通过基板以及散热器基体传到翅片,翅片上的热量再通过热对流以及热辐射与空气进行热量交换,最终将热量散发到空气中。由于芯片热量向基板传输时需要经过蓝宝石衬底,其中蓝宝石衬底的导热性能较差,导致热量无法快速传递到基板,以至于不能尽快散失,主要聚集在有源层与蓝宝石衬底的交界面处,影响了芯片的性能。同时蓝宝石衬底不导电,电极只能在同一端,存在电流扩展问题。通过改变芯片的结构,如利用LED倒装、垂直结构以及改变芯片材料进行散热[17]也取得了良好的效果。陈茂兴等[18]利用(FEM)三维有限元仿真对于传统倒装芯片与平面倒装芯片进行分析,平面倒装芯片有更低的结温和热阻,提供了更好的散热效果。除了改变芯片的结构,还可以改变芯片各层的材料等进行散热优化。白坤[19]通过对于不同功率密度下不同点的温度分布进行监控,研究了石墨烯界面材料和传统导热硅脂材料的散热情况,石墨烯界面材料的综合热学性能更加优异。同时对于石墨烯界面材料设置老化试验,更加体现了该材料的良好性能。罗元等[20]通过分析倒装焊LED的焊球材料、衬底黏结材料和芯片内部热沉材料对芯片结温的影响,得出衬底黏结材料对LED的结温影响最大,并且封装材料热传导系数的变化率与封装结构的传热厚度成反比,与传热面积成正比。 LED系统级散热是在一个系统内完成对于多个芯片的封装,并将散热系统,驱动电路等集成在一起,构成一个系统。系统集成度高,封装兼容性好,将是以后封装发展的趋势[21]。尚洁等[22]在研究时运用Pro/Engineer建模,构建出集成热源、热管、热沉三个主要部分的大功率LED三维散热模型,运用FLoEFD来进行热仿真,通过分析对比得出在LED功率相同的情况下减小热管的有效热阻可以提升大功率LED的散热效果。张阔等[23]通过ANSYS有限元分析软件两种结构得出倒装LED片式光源的散热效果较正装片式光源模组更好。同时倒装LED片式光源基板,可以用于LED串联模组,改变铜电极的数量可以用于不同LED输入电压的需求,可以用于大功率倒装LED芯片。 综上,对于LED封装方式而言,LED散热受多种因素的影响。若要减小高结温对LED各方面性能的影响,应该仔细选取LED散热方式。本文通过Fluent软件进行模拟仿真,在自然对流散热情况下,对SMD封装和COB封装结构的散热性能进行对比分析。同时在COB封装结构下,针对正装、倒装、垂直结构的芯片进行对比分析,为实际研究提供技术支持。 1模型构建 1.1物理模型 COB封装与SMD封装的外封装层主要采用环氧树脂为材料。环氧树脂的导热系数很小,一般只有0.2W/(m·K)左右,热阻很大。故LED芯片产生的热量很难从外封装层散发出去,绝大部分热量通过热传导传递到基板,再由基板与周围环境进行热量交换。因此在仿真时将外封层环氧树脂设置为绝热边界条件,在自然对流情况下,只通过基板与周围环境进行热量交换最终达到动态平衡。同时为了便于模拟仿真,需将两种封装结构进行简化,简化后结构如图所示,图1为SMD封装结构,LED芯片简化成有源层(发光,发热层)和蓝宝石衬底,通过铜热沉用固晶胶与铝基板连接。图2为COB封装的正装结构,图3为COB封装的倒装结构,图4为COB封装垂直结构,不再一一赘述。 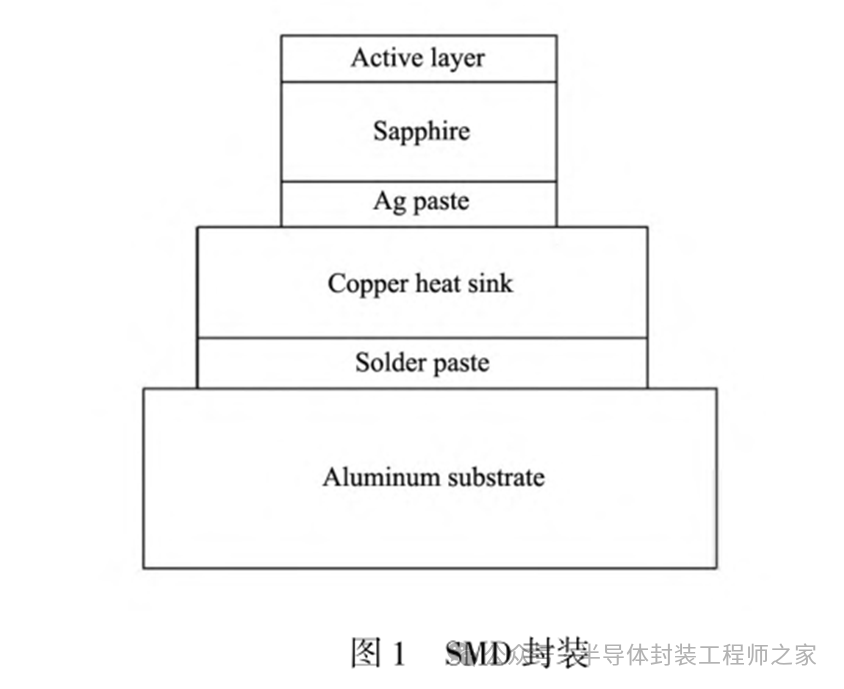 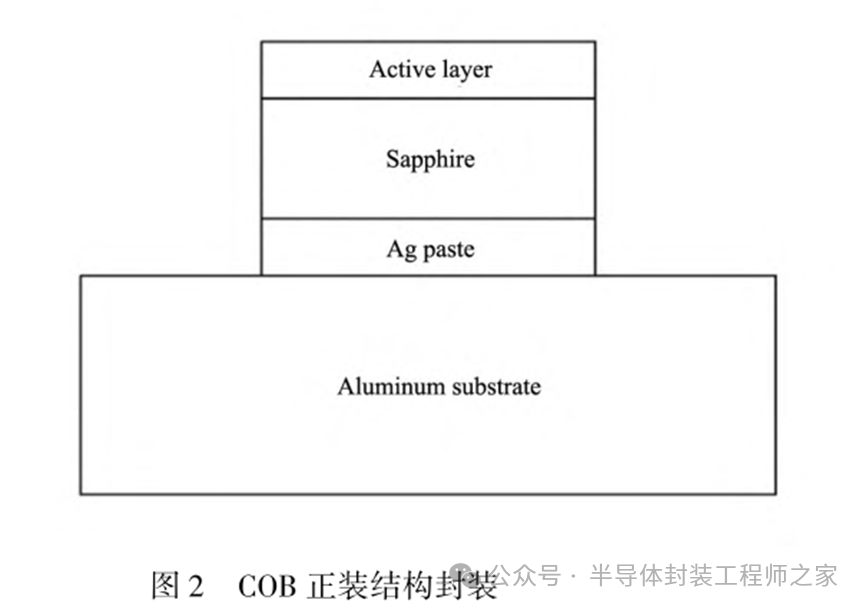 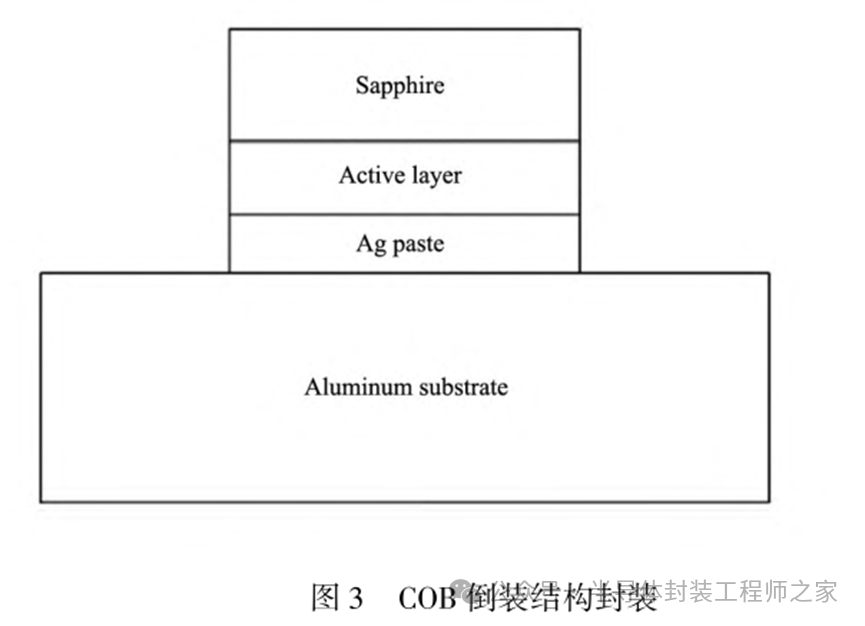 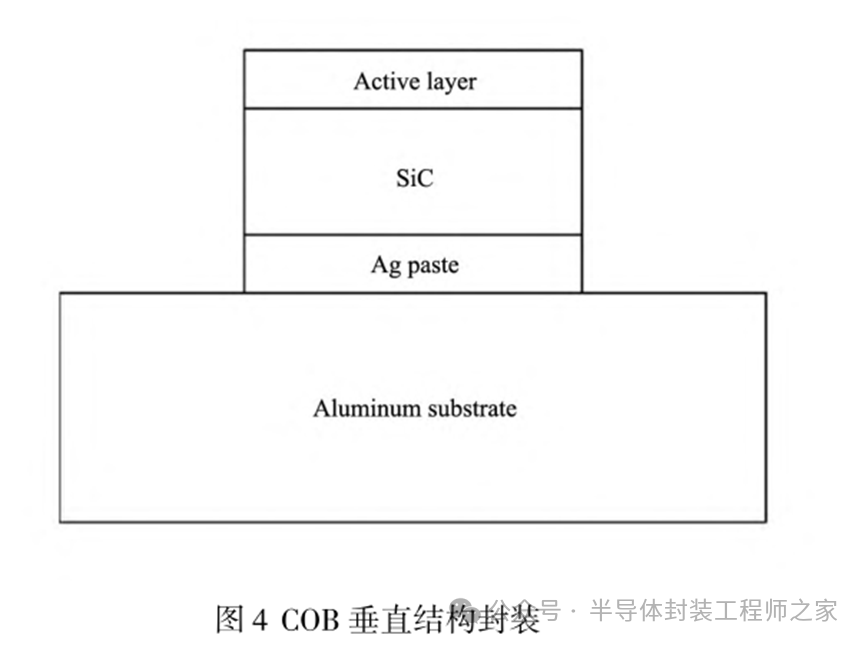 1.2数学模型 模型中热量传递的方式主要是:热传导、热对流,还有很小一部分热辐射。正常情况下,LED芯片通过热辐射散发的热量很小,本文不做热辐射的相关探究。根据能量守恒定律与傅里叶定律,建立导热物体中的温度场应满足的数学表达式,假定导热物体是各向同性的。针对笛卡儿坐标系中微元平行六面体,根据能量守恒定律,通过计算可以得出三维非稳态导热微分方程的一般表达式为:  由上式可知,单位时间传递的热量与物体的热导率、密度、比热容、热源等因素有关。表1为LED芯片材料的物性参数。  模型采用相同尺寸大小的铝基板,LED有源层产生的热量传递到铝基板后,主要通过自然对流进行散热。对流散热计算公式为  式中:Q为对流散热量,单位:W;h为换热系数,单位:W/(m2·K);A为换热面积,单位:m2;△t为换热表面与流体温差,单位:K。影响对流换热的因素很多,如流体流动的起因、流动的状态、换热表面的几何因素、物理因素等。 2散热仿真模拟 目前LED的发光效率约为20%~30%,其余70%~80%的能量都转化为热量。假设80%的能量都转化为热量,且产热量恒定不变。若取0.1W的LED灯,其中80%的转化为热量,即0.08W。假设LED热源体积为1mm×1mm×0.1mm。因此单位时间、单位体积所产生的热量为  设置环境温度为300K,自然对流换热系数为10W/(m2·K)。散热基板为10mm×10mm×1mm,其中上表面1mm×1mm处被芯片所覆盖,则有效散热面积A=239mm2。对于LED封装结构进行设计时可以先进行仿真模拟分析,与目标性能进行对比分析,然后再进行实验操作。具体仿真过程读者可参考文献[24]。 3结果与讨论 3.1不同封装类型对于散热效果的影响 选取市场上应用比较广泛的两种LED封装类型:SMD封装和COB封装进行对比分析。SMD封装结构依次为有源层、蓝宝石衬底、银胶、铜热沉、锡膏、铝基板。COB封装结构依次为:有源层、蓝宝石衬底、银胶、铝基板。图5显示的是COB正装和SMD封装时的温度分布,由仿真结果可见,当功率为0.06W时,在热平衡条件下,COB封装和SMD封装的芯片结温基本相同,但是随着功率的增加,如图6所示,LED结温几乎线性增加,且COB封装的散热效果明显优于SMD封装。结合理论和实验分析,其结果主要是由于系统热阻不同,SMD封装增加了结构热阻和接触热阻,导致传热效果相对更差。相比于SMD封装,COB封装结构简单,制作工艺流程少,故逐渐替代SMD封装,成为现在市场上应用比较广泛的LED封装类型。 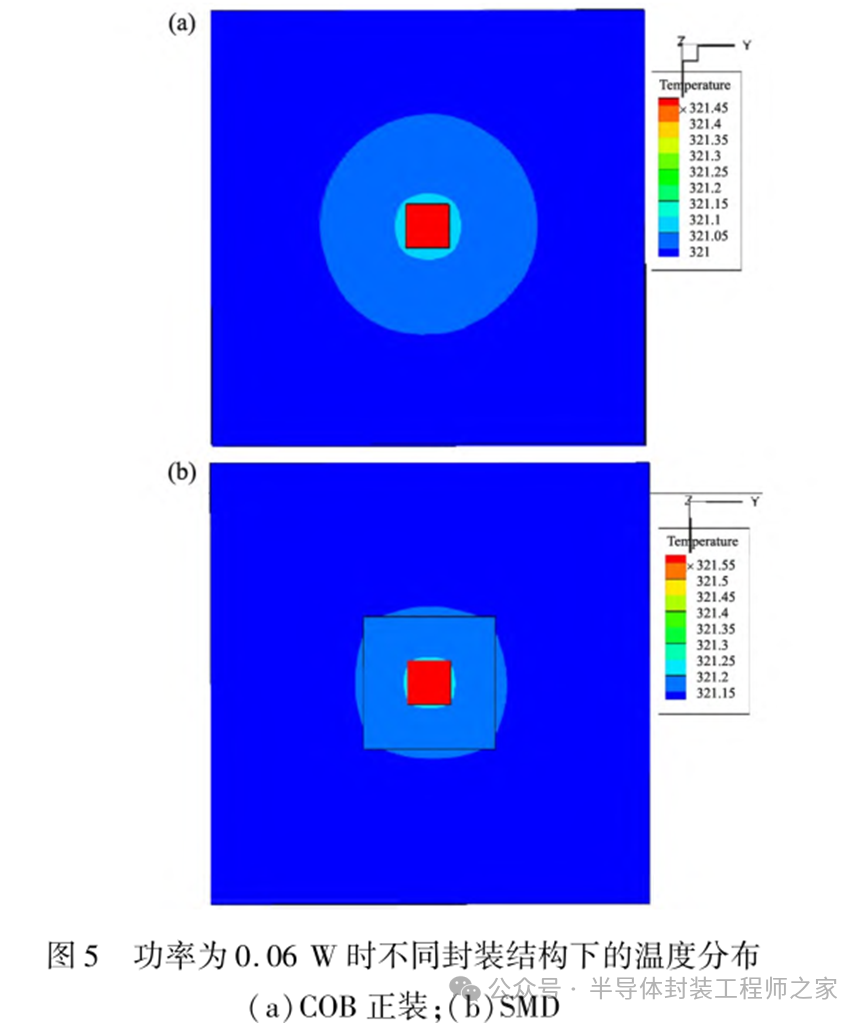 3.2不同芯片结构对于LED散热的影响 目前市场上的LED芯片主要为正装结构,主要是因为LED正装结构制作工艺比较成熟,价格便宜。由于蓝宝石衬底不导电,只能制备同侧电极,故正装结构存在横向电流结构局限性、导热性能差等导致热失效问题。LED垂直结构采用可导电的SiC衬底,可以改善同侧结构带来的影响。同时为了解决蓝宝石衬底热导率较差的问题,一些研究者制备出了LED倒装结构。由图6可知,在COB封装下,不同LED芯片结构散热效果不同。LED垂直结构采用了SiC衬底,其热导率较蓝宝石衬底大,因此具有更小的热阻,故散热性能更好。LED倒装结构解决蓝宝石衬底热导率较差的问题,使LED有源层更紧密地接触散热基板,热阻相对于其他两组更小,故COB倒装结构封装散热效果最优。由于LED倒装结构制备工艺不成熟,成本较高,对于LED光通量有一定的影响等因素限制了LED倒装结构广泛进入市场。此外,制备LED垂直结构最合适的SiC衬底主要由美国Cree公司掌握其独特的生长技术,知识产权受到限制。目前主流为在蓝宝石衬底上生长GaN外延层再进行剥离制备垂直结构,由于蓝宝石衬底质地坚硬且耐腐蚀,只能采用激光剥离的方式将原先衬底去除,导致其他层材料受损。在大规模生产过程中,可操作性及可重复性较差,成本较高。  3.3不同基板尺寸对于散热的影响 采取了6种不同尺寸的散热铝基板进行仿真,基板规格分别为:6mm×6mm×1mm、7mm×7mm×1mm、8mm×8mm×1mm、9mm×9mm×1mm、10mm×10mm×1mm和11mm×11mm×1mm。LED功率均为0.1W。由图7可知,3种COB封装下,芯片结温具有一致性,且随着基板尺寸的增大,LED结温减小,但LED结温变化率减小。即继续增加基板尺寸,LED散热效果提升不明显。根据曲线的变化趋势,可以推断,随着基板尺寸的增加,3种LED封装下的结温将趋于某一稳定的数值。此后再继续增加基板尺寸,LED结温将不再变化。当基板为6mm×6mm×1mm时,LED结温为113℃,如果基板尺寸继续减小,将会达到LED最高允许结温120℃,造成芯片永久损伤,不能使用。此时可以通过增加翅片等[24]方式来增加散热。 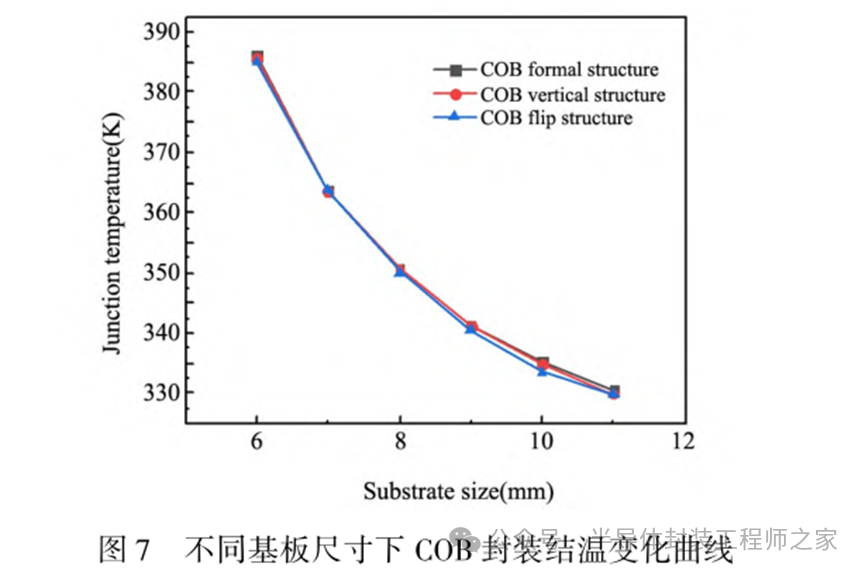 4结论 利用Fluent软件对LED散热过程进行仿真,研究在自然对流情况下,不同类型封装结构对于LED散热性能的影响。通过实验数据分析,可以得到以下结论。 (1)相比于COB封装,SMD封装的散热效果相对较差。其主要原因是SMD封装增加了封装的接触热阻和结构热阻。由于COB封装具有更小的尺寸,以及良好的散热性能,目前在市场上占据了一席之地,并逐渐取代SMD封装,成为市场LED的主流封装结构。 (2)在3种COB封装类型中,LED倒装结构芯片散热效果最好,其次是垂直结构,最后是正装结构。LED垂直结构采用导电的SiC衬底相较于蓝宝石衬底有更小的热导率,散热性能更好。LED倒装结构使LED有源层更紧密地接触散热基板,有着更加良好的散热效果。两者主要都是通过减少热阻以此增加散热。因此可以在保证功能的前提下,尽量减小热阻来增加散热效果。 (3)随着基板尺寸的增大,LED结温减小,但LED结温变化率也随基板尺寸增大而减小,散热效果提升不明显。因此可以通过综合考虑材料、成本等选择合适的基板尺寸,以实现最优性价比。 由于制作工艺复杂、成本较高、知识产权受限等各方面因素限制了LED垂直结构和倒装结构进入市场,正装结构COB封装占据市场主导地位。如果可以将这些问题解决,凭借倒装结构良好的散热性能,必定可以占据一定市场,甚至可以取代正装结构COB封装。 |





