|
芯片可靠性测试主要分为环境试验和寿命试验两个大项,可靠性测试是确保芯片在实际应用中能够稳定运行和长期可靠的关键步骤。一般来说,可靠度是产品以标准技术条件下,在特定时间内展现特定功能的能力,可靠度是量测失效的可能性,失效的比率,以及产品的可修护性。根据产品的技术规范以及客户的要求,我们可以执行MIL-STD、JEDEC、IEC、JESD、AEC、EIA等不同规范的可靠度的测试。  一、HTOL:高温寿命试验 高温寿命试验也叫老化测试,是一种常用的芯片可靠性测试方法,通过将芯片在高温环境下长时间运行,以模拟实际使用中的热应力和老化过程。这种测试有助于评估芯片在高温环境下的稳定性和长期可靠性。在进行热老化测试时,芯片通常被放置在具有恒定高温的环境中,持续运行一段时间,常见的测试温度范围为100°C至150°C。测试期间,芯片的电气特性、性能和可靠性会被监测和记录。 通过热老化测试,可以检测到由于热扩散、结构破坏或材料衰变等原因引起的故障。这些故障可能包括电阻变化、电流漏泄、接触不好、金属迁移等。通过分析测试结果,可以评估芯片在长期高温环境下的可靠性,并为改进设计和制造过程提供参考。  也可以通过批量的高温老化测试对一些复杂芯片或者高可靠性要求的芯片/模组进行生产型高温老化测试筛选,从而将早期失效的潜在风险DUT筛选出去,以提高产品的整体良率和一致性。生产型高温老化测试在NAND Flash、车规级MCU/MPU/DSP、高可靠性电源,和高复杂度的CPU、GPU、以及其他AI算力/互联芯片市场有广泛应用。其要求在老化的过程中对被测芯片(DUT)进行持续动态监测,并通过log文件对测试后的DUT进行分选。 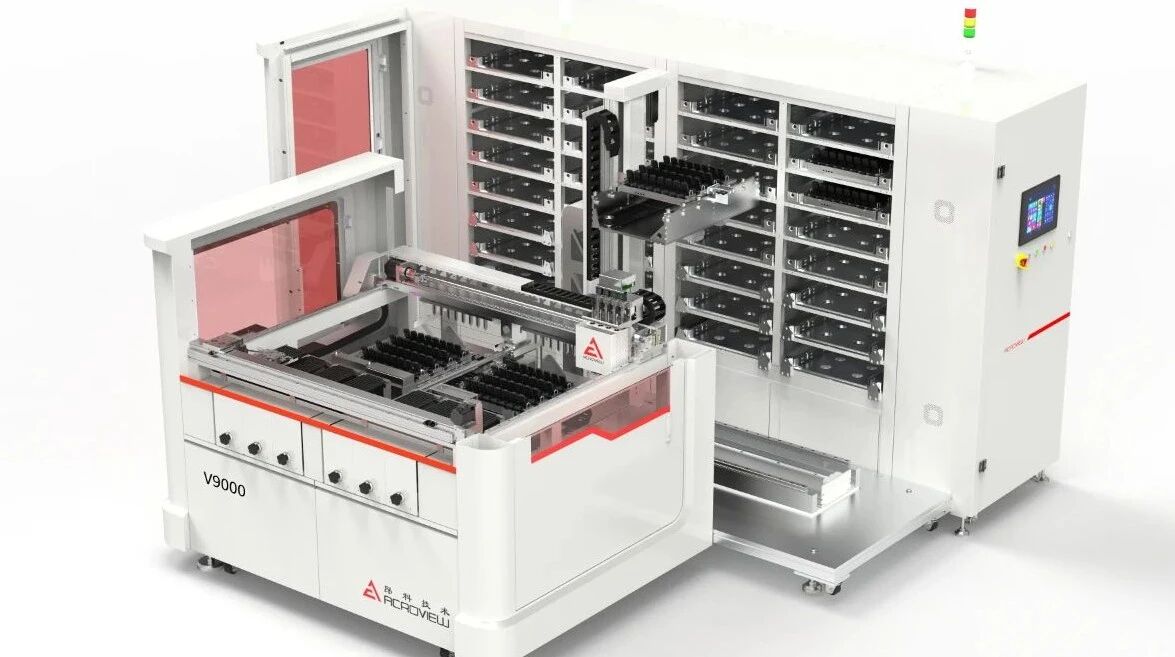 随着AI技术的发展,AI大模型算力服务器的大量部署越来越成为了各个大国科技竞争的必争高地,高算力的GPU、CPU、FPGA和其他高速互联芯片被大量应用。而在端侧,也随着更多端侧大模型的不断提升算力需求,应用在汽车电子、IoT领域的高算力芯片也应运而生。这些AI应用都指向了一个显著的变化,单个SOC的功耗越来越大,而且芯片的复杂程度也越来越高。因此,支持高功率SOC动态老化测试的BI测试设备需求也是行业重要痛点。昂科的V9000-BI系列单个DUT最高功率支持1500W,比此前业内最高功率耗散能力提升50%,为高功率AI芯片的老化测试提供最佳的解决方案。 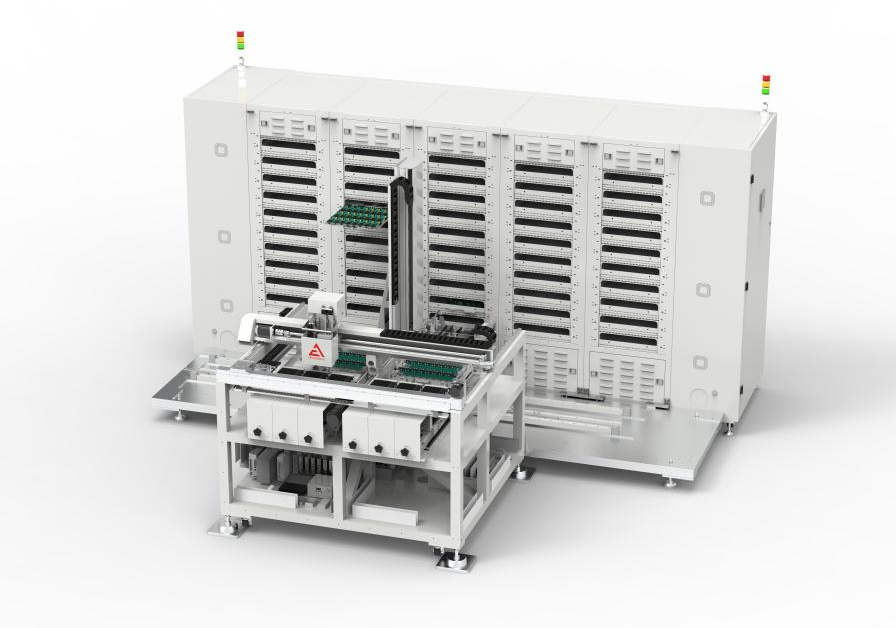 V9000-BI-H系列超高功率全自动老化测试机,是专门针对于GPU/NPU/CPU等超高功率算力芯片的老化测试,其产品主要特点如下: ✔全自动老化测试,支持全自动上下料、Tray自动分配、测试后自动分BIN ✔高精度CCD视觉检测,产品定位及识别防错 ✔自动收集测试log,并支持MES系统对接,保证测试过程的可追溯性 ✔全流程ESD防护,测试/分选环境多台离子风机 ✔支持单DUT功耗最高至1500W ✔单DUT独立温控Socket,定制化水冷散热模组 ✔测试库最高可容纳32个独立的BIB板 ✔单板可支持16路高功率独立可编程电源(380W, 250A, 0.3Vto2V) ✔单板可支持16路低功率独立可编程电源(60W, 15A, 0.3Vto4.0V) ✔向量深度高达64M(可选128M)并行向量深度 ✔8G扫描向量深度 ✔128 I/O格式化数字向量通道,另有128单向输出向量通道 ✔16路专用通道提供100MHz快速扫描测试模式 ✔8路可编程高频时钟,最高350MHz (LVDS to BIB) ✔支持独立的冷水机以便于维护  二、TCT:高低温循环试验 温度循环测试旨在评估芯片在温度变化环境下的稳定性和可靠性。这种测试模拟了实际使用中由于温度变化引起的热应力和材料疲劳。在温度循环测试中,芯片会在不同温度之间进行循环暴露。通常,测试会在两个或多个不同的温度点之间进行切换,例如从低温(如-40°C)到高温(如125°C)。每个温度点的暴露时间可以根据需要进行调整。  通过温度循环测试,可以检测到由于温度变化引起的结构应力、热膨胀差异、焊点疲劳等问题。这些问题可能导致接触不好、焊连断裂、金属疲劳等故障。测试期间,芯片的电气特性、性能和可靠性会被监测和记录。 三、EFR/ELFR:早期失效寿命试验 早期失效寿命试验旨在评估芯片在其使用寿命的早期阶段内是否存在任何潜在的故障或失效。这种测试通常在芯片制造过程中或产品开发的早期阶段进行。它涉及加速测试和高度应力环境下的芯片运行。通过施加高温、高电压、高频率等条件,使芯片在短时间内暴露于更严苛的环境,以模拟实际使用中的应力情况。早期失效寿命试验的目标是提前发现潜在的故障和不佳,以便进行适当的改进和调整。通过分析测试结果,可以确定芯片设计和制造过程中的弱点,并采取相应措施来提高芯片的可靠性和寿命。 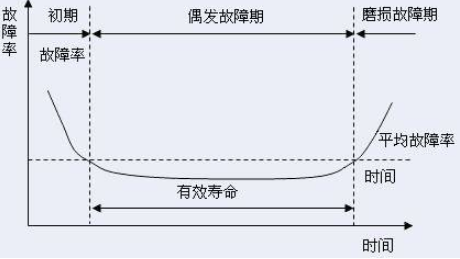 四、UHAST:加速应力测试 芯片的UHAST测试是通过施加限值的电压和温度条件来加速芯片在短时间内的老化和故障模式。具体的UHAST测试条件,包括高温、高湿、压力和偏压值,以下是一些常见的UHAST测试条件的参考数值。 高温:通常在大约100°C至150°C的温度范围内进行,具体温度取决于芯片的设计要求和应用环境。有时候,更高的温度也可能被用于特殊情况下的测试。 高湿度:一般的UHAST测试中,相对湿度通常保持在85%至95%之间。高湿度条件下会加剧芯片的老化和腐蚀。 压力:测试期间施加的压力可以通过测试装置或封装环境来实现。压力的具体数值通常在2至20大气压之间,具体数值取决于测试要求和芯片的应用场景。 偏压:偏压通常指施加在芯片引脚或器件上的电压。具体的偏压数值取决于芯片的设计和应用需求。在UHAST测试中,偏压可以用于加速故障模式的产生,例如漏电流、击穿等。  五、BLT:偏压寿命试验 BLT用于评估MOS FET(金属氧化物半导体场效应晶体管)等器件在长期偏置和高温环境下的稳定性和可靠性。在BLT偏压寿命试验中,芯片会被加以恒定的偏置电压,并暴露于高温环境中。偏置电压通常是根据具体芯片规格和应用需求进行设定的。在持续的高温和偏置条件下,芯片的特性、性能和可靠性将被监测和记录。 BLT测试的目的是检测由于偏压和高温环境引起的偏压老化效应。这些效应可能导致硅介质的损失、界面陷阱的形成和能带弯曲等问题。测试结果可以用于评估芯片在长期使用和高温环境下的可靠性,并为设计和制造过程的改进提供参考。 六、BLT-LTST:低温偏压寿命试验BLT-LTST用于评估MOS FET等器件在低温、长期偏置和高压环境下的稳定性和可靠性。在BLT-LTST低温偏压寿命试验中,芯片会被暴露于低温环境,并施加恒定的偏置电压和高压。低温条件通常在-40°C至-60°C范围内设定,具体取决于芯片规格和应用需求。在持续的低温、偏置和高压条件下,芯片的特性、性能和可靠性将被监测和记录。BLT-LTST测试的目的是检测由于低温偏压和高压环境引起的可靠性问题。这些问题可能包括硅介质的损失、漏电流增加、接触不好等。通过分析测试结果,可以评估芯片在低温和偏压环境下的可靠性,并提供改进设计和制造过程的参考。  |





