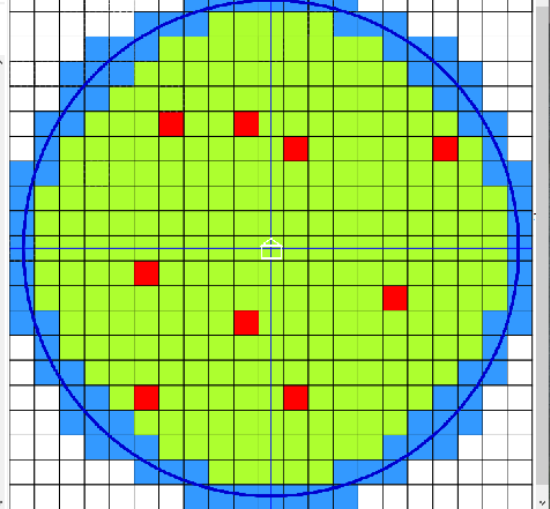 使用晶圆验收测试来监控整个晶圆的关键参数是否一致,以提高产量并减少缺陷。 为什么进行WAT? WAT是晶圆制造的一个重要站点,它是用来检测(也称检验)已经制造完成的晶圆上,各种器件的各方面电学性能(Electrical Performance)是否满足规格要求。如果某些重要参数没有符合要求,晶圆将会被报废,不会进入下一阶段。
WAT数据的生成和处理 众所周知,建造、采购和运营制造集成电路的代工厂的成本很高。Fabless公司避免了这种重资本的成本,并专注于其专业领域的设计和创新。
另一方面,Fabless公司依靠代工厂的专业知识和技能来生产优质晶圆。很多时候,无晶圆厂公司用于制造晶圆的工艺与许多其他公司共享。铸造厂将在制造的每个阶段进行质量监控和过程控制测试。当晶圆准备好发货时,生产线末端的数据可供无晶圆厂客户使用。 晶圆验收测试 (WAT),其实也称为过程控制监控 (PCM) 数据,是晶圆厂在制造结束时生成的数据,通常提供给无晶圆厂客户的每个晶圆数据通常会有 40 到 100 次测试,每次测试都有晶圆上每个位置(或“插入”)的结果。这些站点的位置使晶圆厂可以监控整个晶圆的关键参数的一致性。在工厂内部,有一个统计过程控制系统,它使用这些(和其他)数据来提高产量并减少缺陷。 通常,数据是按批次发送的,因此 25 个晶圆表示在一个数据文件中。格式通常是 ASCII CSV(逗号分隔值)或 Excel。任何现代产量管理系统 (YMS) 或产量分析系统都将能够支持此类数据。
从晶圆厂传输数据
通常晶圆厂位于亚洲,但有些仍位于欧洲和美国。无论它们位于何处,WAT 数据通常都必须传输到 YMS 中进行处理。YMS 供应商应提供一种安全的方法(脚本)将数据从工厂传输到他们的系统。如今,YMS 通常在云端或“本地”中。大多数无晶圆厂公司更喜欢外包 YMS,尤其是当他们开始拥有合理的数量并且供应商应该能够为客户提供云和On Premise 选项时。  指示有九个 WAT 位点的晶圆
处理数据
当 WAT 数据到达 YMS 传入目录时,它通常按晶圆 ID 进行拆分。然后将每个晶圆的数据拆分到每个站点(或晶圆上的测试位置)。站点的数量可以从五个到九个不等,有时在专业芯片中要多得多。然后,每个站点通常会有 60 个结果。这些结果从“关键”参数到“监控”参数不等。许多测试,尤其是关键测试,都会有限制。因此,所有这些数据都被输入 YMS 并可供分析。一个好的 YMS 系统会在几秒钟内将这些数据自动处理到数据库中。应该不需要手动处理数据。数据大小远不及晶圆分类和最终测试的STDF (或等效)数据的大小。实际上,它远小于 YMS 数据库大小的 1%。例如,本文中使用的 WAT 数据有 62 个参数,跨越 9 个站点,压缩后大小为 75KB。同一批次的相关晶圆分类数据压缩为 1GB。因此,WAT 数据表现得非常好(当然与某些晶圆不同!),体积小,有助于快速分析和可视化。

可视化 WAT 数据
在图 4中,您可以看到测试 Isat_1P3 的完整批次的 WAT 数据。如您所见,每个晶圆的相同位置使用相同颜色的趋势线连接在一起。该数据集中的 Wafer 12 site 5(蓝色)与其他数据明显不同。此外,晶圆 1 的 Isat 测试范围比晶圆 12 以外的其他晶圆更大。
 所有 40 个批次(1000 个晶圆)的 WAT 参数趋势 将 WAT 数据与晶圆分类和最终测试相关联 一旦您有办法在整个供应链中连接来自相同晶圆的数据,那么您的 YMS 就会释放出更多的力量。如果连接是自动化的,那就更好了——那么您就有可能快速真正地看到相关性,而无需任何手动准备。图 5 是 WAT 参数平均值(Y 轴)与晶圆分类中箱的失败率(x 轴)的示例。在此示例中,fab 参数的限制远远超出此图表范围。基于这是一个示例,说明 WAT 数据的重要性、其可视化的重要性以及与来自晶圆分类和最终测试的测试数据的链接有多重要。  除了本介绍的范围之外,还有其他分析 WAT 数据的方法。例如,WAT 站点的结果可以与晶圆分类中该部分晶圆的参数和仓性能相关联。 |