本文就SiC-MOSFET的可靠性进行说明。这里使用的仅仅是ROHM的SiC-MOSFET产品相关的信息和数据。另外,包括MOSFET在内的SiC功率元器件的开发与发展日新月异,如果有不明之处或希望确认现在的产品情况,请联系我。一、 ROHM SiC-MOSFET的可靠性 1、 栅极氧化膜ROHM针对SiC上形成的栅极氧化膜,通过工艺开发和元器件结构优化,实现了与Si-MOSFET同等的可靠性。 CCS TDDB(Constant Current Stress Time Dependent Dielectric Breakdown:恒流经时绝缘击穿)试验中,栅极氧化膜可靠性的指标–QBD(Charge to Breakdown)为15~20C/cm2,与Si-MOSFET同等。 另外,在旨在确认有关晶体缺陷的栅极氧化膜可靠性的HTGB(High Temperature Gate Bias:高温栅极偏压)试验(+22V、150℃)中,在装置中未发生故障和特性波动,顺利通过1000小时测试。 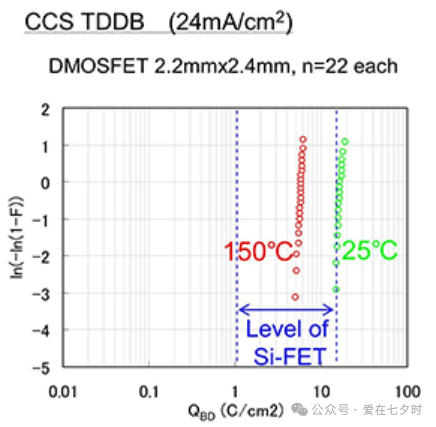 添加图片注释,不超过 140 字(可选) 2、 阈值稳定性(栅极正偏压)SiC上形成的栅极氧化膜界面并非完全没有陷阱,因此当栅极被长时间施加直流的正偏压时,陷阱捕获电子而使阈值上升。 经HTGB试验证实,阈值偏移非常小,在Vgs=+22V、150℃的条件下1000小时后,仅为0.2~0.3V。大多数陷阱在施加应力初期的几十个小时内被填充,其后几乎没有变化,很稳定。  添加图片注释,不超过 140 字(可选) 3、 阈值稳定性(栅极负偏压)反之,当栅极被长时间施加直流的负偏压时,空穴被捕获,阈值下降。在HTGB试验中,负偏压下的阈值变化程度大于正偏压,在Vgs为-10V以上时阈值下降超过0.5V。 第二代MOSFET(SCT2[xxx[]系列、SCH2xxx]系列)中,栅极负偏压的保证电压为-6V。请注意,当负偏压大于-6V时,阈值可能进一步降低。交流(正负)偏压时,反复进行对陷阱的充放电,因此偏移的影响很小。 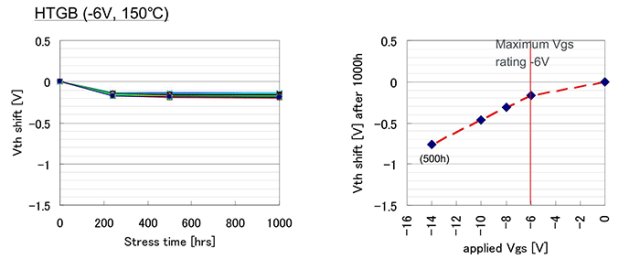 添加图片注释,不超过 140 字(可选) 二、 体二极管的通电劣化 一般认为SiC-MOSFET存在称为“体二极管的通电劣化”的故障模式。这是正向电流持续流过MOSFET的体二极管时,电子-空穴对的重新复合能量使称为“堆垛层错”的缺陷扩大,影响到电流路径,使导通电阻和体二极管的Vf上升的模式。 堆垛层错使发热量增加,在某些情况下还会引起耐压性能下降。因此,在用于发生向体二极管换流的应用(逆变器、DC/DC转换器等)时,有可能会导致问题。(※在SBD和MOSFET的第一象限工作中不会发生这类问题) ROHM通过开发不会扩大堆垛层错的独特工艺,成功地确保了体二极管通电的可靠性。在1200V 80Ω的第二代SiC MOSFET产品中,实施了对体二极管进行1000小时的直流8A通电测试,结果如下。试验证明,所有特性如导通电阻,漏电流等都没有变化。  添加图片注释,不超过 140 字(可选) 1、 短路耐受能力由于SiC-MOSFET与Si-MOSFET相比具有更小的芯片面积和更高的电流密度,因此对于导致热击穿的短路的耐受能力往往比Si-MOSFET低。TO247封装的1200 V级MOSFET中,Vdd=700V、Vgs=18V时的短路耐受时间约为8~10μs。随着Vgs降低,饱和电流减小,所以耐受时间变长。另外,Vdd较低时发热量也会减少,所以耐受时间会更长。 由于关断SiC-MOSFET所需的时间非常短,所以当Vgs的断路速度很快时,急剧的dI/dt可能会引发较大的浪涌电压。请使用逐渐降低栅极电压的软关断功能等,并在没有过电压的情况下关断。 2、 dV/dt破坏Si-MOSFET存在一种由于dV/dt过高而通过电容Cds流过瞬态电流,寄生双极晶体管工作导致损坏的模式。ROHM的SiC-MOSFET由于寄生双极晶体管的电流放大倍数hFE较低,因而不会发生电流放大,截至目前的调查中,即使在50kV/µs左右的工作条件下,也未发生这种损坏模式。关于体二极管快速恢复时的dV/dt,一般认为由于SiC-MOSFET的快速恢复电流非常小,快速恢复时的dI/dt很小,所以dV/dt也不会增加,不易发生这种损坏模式。 3、 宇宙射线引起的中子耐受能力在高原应用中,受宇宙射线影响,少数进入地面的中子或重离子有时会引发半导体器件的单粒子效应,这已成为需要解决的问题。在对SiC-MOSFET(n=15)进行的白色中子照射试验(能量:1~400MeV,由大阪大学核物理研究中心RCNP实施)中,在Vds=1200V(额定耐压的100%)条件下实施1.45×109 neutrons/cm2/s的中子照射后,结果并未发生由于单粒子效应引发的故障。海拔0m处的故障率为0.92FIT,海拔高度4000m处也仅为23.3FIT,故障率比同等级Si-IGBT和Si-MOSFET低3~4个数量级。耐压实力值更高,并具有足够的余量,从而可以在高原应用或多个使用的应用中,降低因宇宙射线引起的中子诱发故障的风险。 4、 静电击穿耐受能力SiC-MOSFET的优点是芯片尺寸可以比Si-MOSFET小,但另一方面,静电击穿(ESD)耐受能力却较低。因此,处理时需要采取充分的防静电措施。 静电对策举例 ・利用离子发生器除去人体、元器件、作业环境中的静电(推荐) ・利用腕带、接地除去人体、作业环境中的静电(元器件带电时无效,所以仅此对策还不够) 三、 各种可靠性试验结果 以日本广泛采用的JEITA(原“EIAJ”)ED-4701作为用来评估半导体的测试方法,其可靠性试验结果如下。从结果可以看出,ROHM的SiC-MOSFET具有足够的可靠性。  添加图片注释,不超过 140 字(可选)  添加图片注释,不超过 140 字(可选)  添加图片注释,不超过 140 字(可选) 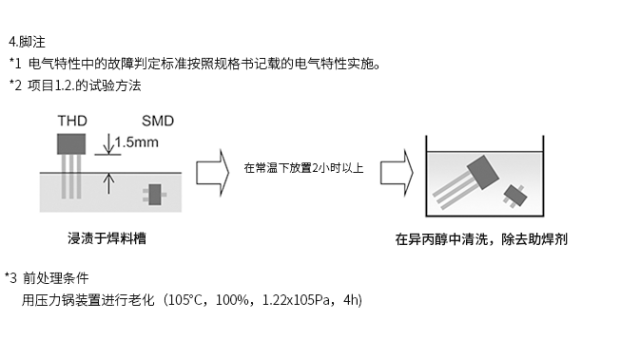 |





