
本文目录:
为什么要测试,为什么分开测试?
CP测试和FT测试的具体不同
主要测试项
CP和FT测试,对芯片设计有什么要求
1为什么要测试,为什么要分开测试
为什么要测试?
芯片设计好,晶圆厂进行生产的过程,是化学反应和物理操作的过程(晶圆工艺),不同晶圆厂的工艺成熟度,性能不一样,可能导致芯片的功能,性能差别,不一定能够满足客户需求(比如功耗需求,电气特性需求等),因此要设计测试方案,把不符合要求的剔除出来;
为什么分开测试?
芯片测试一般会分2大步骤,一个叫CP(Chip Probing),一个叫FT(Final Test)
CP是针对晶圆的测试,FT是针对封装好的芯片的测试,流程如下

分两个步骤,主要是如何最高的性价比,把合格芯片挑选出来;
FT因为是针对封装好芯片的测试,因此芯片的引线,基板,封装材料这些已完成,成本都在,如果晶圆DIE是坏的,那就浪费了
CP测试的目的,就是在封装前就把坏的芯片DIE筛选出来;
如下是晶圆的不同区域对应的Yield Rate(良率),可以看到越靠晶圆旁边的位置,良率越低
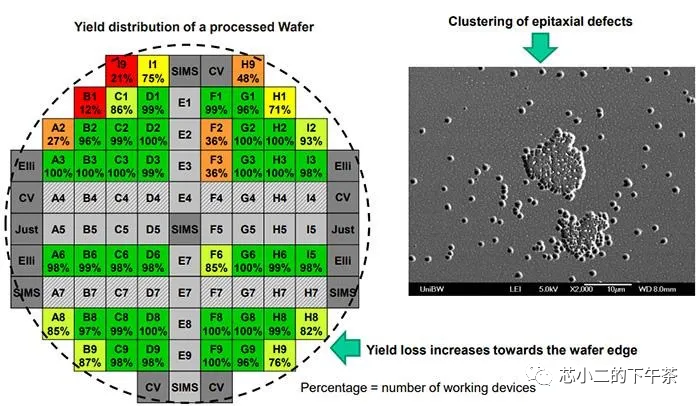
转自 知乎温戈
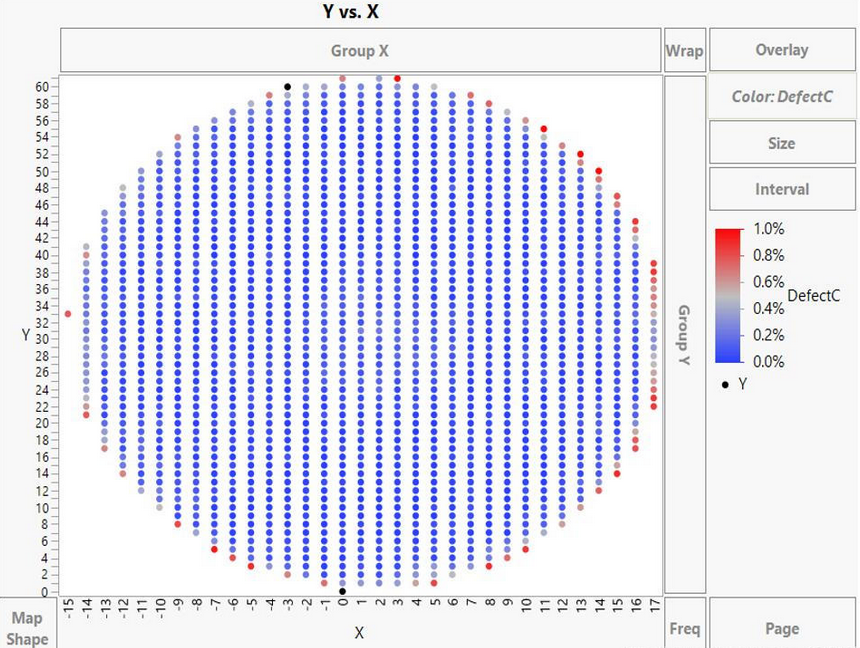
图片转自 网络不知名
2 CP测试和FT测试的不同
逆因为一个测试对象载体在晶圆(一个晶圆一般有上千颗芯片),一个测试对象是封装好的芯片,因此其测试最大的不同是测试用的设备
如下是CP测试示意图,测试用探针卡,从ATE测试设备上显微镜看到的具体操作图片,以及正在操作的ATE设备

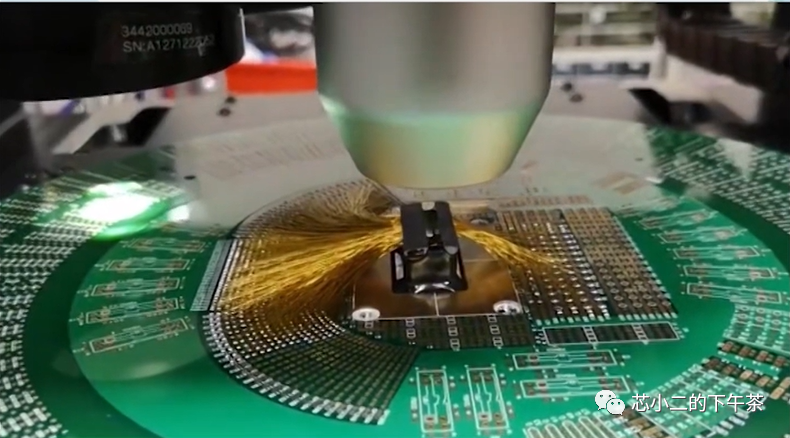
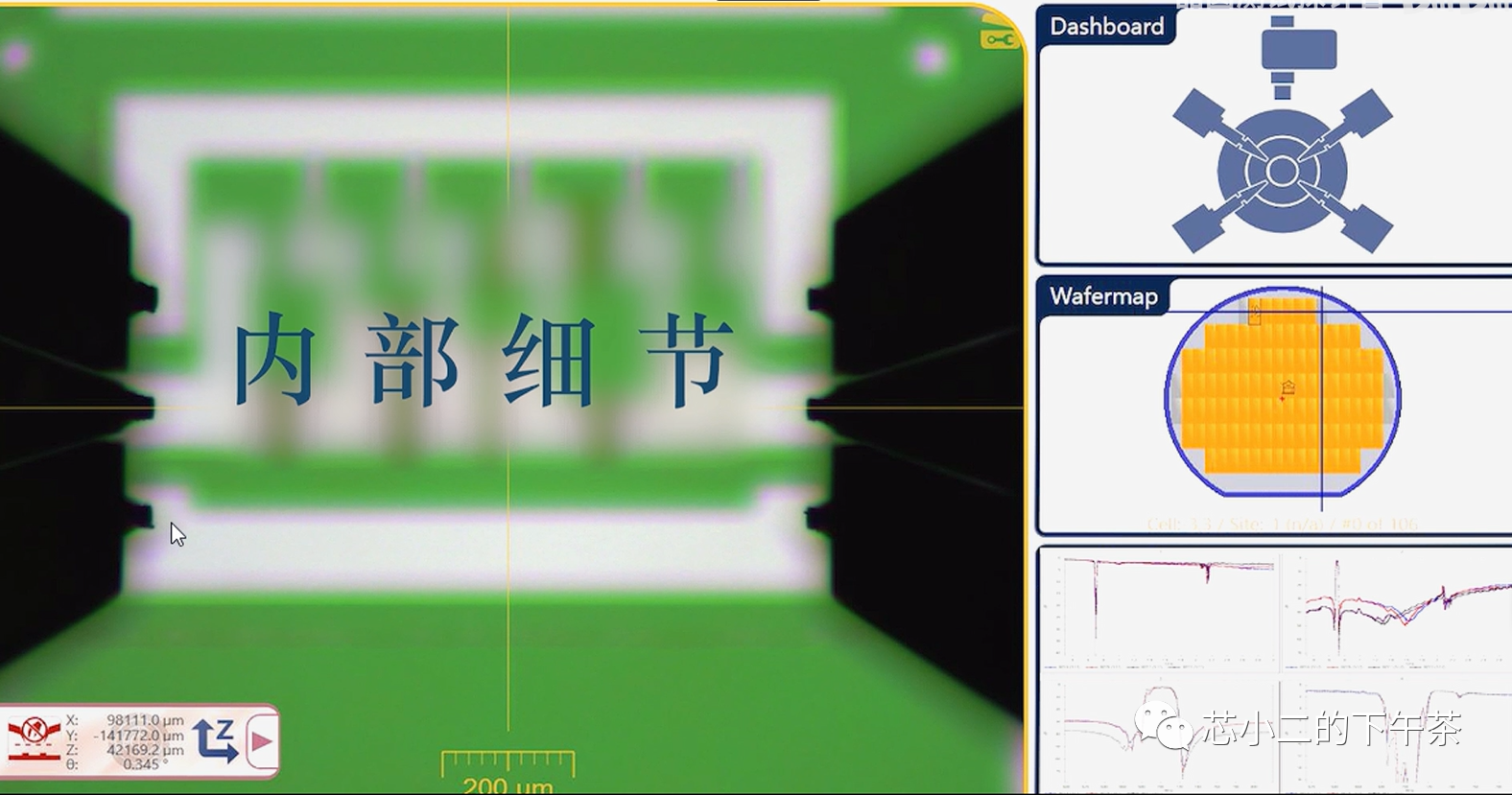

ATE设备基于编写好的程序(测试用例),对晶圆上的每一颗芯片进行测试,这里探针的移动距离在0.Xum级别一般
而FT部分,大家可能会更加好理解,因为平时大家做测试板的类似,主要区别可能就是FT测试用Socket座子(因为测试完成要取出来)

为了提高效率,一个测试板上可以放很多这样的Socket座子;
因为CP和FT在不同阶段,其测试对象,测试工具的差异带来的限制,测试侧重点会不一样
CP测试阶段会尽可能覆盖对良率影响大的用例,比如短路,逻辑功能,内部存储;
CP因为采用了探针,对于高速信号,小信号,大电流方面的测试,一般不合适,会放到FT去测试;
3主要测试项
本章节主要参考资料:知乎温戈
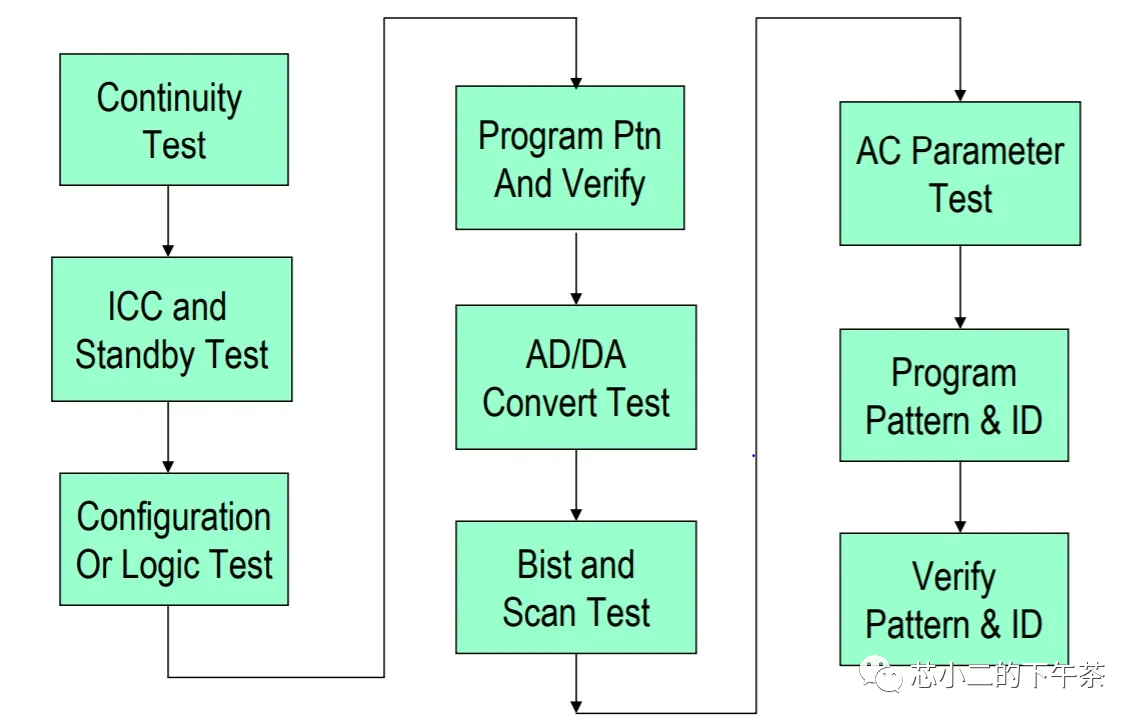
DC性能测试
Continuity Test
Continuity Test
Leakage Test (IIL/IIH)
Power Supply
Current Test (IDDQ)
Other Current/Voltage Test (IOZL/IOZH, IOS, VOL/IOL, VOH/IOH)
LDO,DCDC 电源测试
以Continuity测试举例,主要是检查芯片的引脚以及和机台的连接是否完好
测试中,DUT(Device Under Test)的引脚都挂有上下两个保护二极管,根据二极管单向导通以及截至电压的特性,对其拉/灌电流,然后测试电压,看起是否在设定的limit范围内

转自 知乎温戈
整个过程是由ATE里的instruments PE(Pin Electronics)完成
AC参数测试
主要是AC Timing Tests,包含Setup Time, Hold Time, Propagation Delay等时序的检查
特别外设功能测试(ADC/DAC)
主要是数模/模数混合测试,检查ADC/DAC性能是否符合预期,主要包括静态测试和动态测试:
Static Test – Histogram method (INL, DNL)
Dynamic Test – SNR, THD, SINAD
数字功能测试
这部分的测试主要是跑测试向量(Pattern),Pattern则是设计公司的DFT工程师用ATPG(auto test pattern generation)工具生成的
Pattern测试基本就是加激励,然后捕捉输出,再和期望值进行比较。
与Functional Test相对应的的是Structure Test,包括Scan,Boundary Scan等
SCAN是检测芯片逻辑功能是否正确
Boundary SCAN则是检测芯片管脚功能是否正确
BIST(Build In Self Test),检查内部存储的读写功能是否正确
4对芯片设计的要求
在设计阶段,就需要考虑如何支撑芯片的测试要求,这在芯片设计里面有一个专门的岗位,DFT工程师 (Design For Test)
DFT逻辑通常包含SCAN、Boundary SCAN、各类BIST、各类Function Test Mode以及一些Debug Mode
测试人员需要在芯片设计之初就准备好TestPlan,根据各自芯片的规格参数规划好测试内容和测试方法,并和DFT工程师及其他设计人员讨论
|