  预处理 Precondition Test(Pre-con)介绍 芯片应用于终端系统上,需要将芯片焊接于PCB板上,与周边相关元件、电路相互连接,共同组成系统板以提供全面的系统功能。然而在组装上板之前,芯片须经历运输至组装厂、储存、上板等流程。在等待的过程中,因为暴露于车间的时间,使得芯片吸收了湿气,而在高温环境的回焊作业下,因为湿气及温度变化的影响,造成失效的情况发生。 Pre-con实验主要在模拟芯片在运输、上板使用等过程,所经历的环境变化。  实验流程: 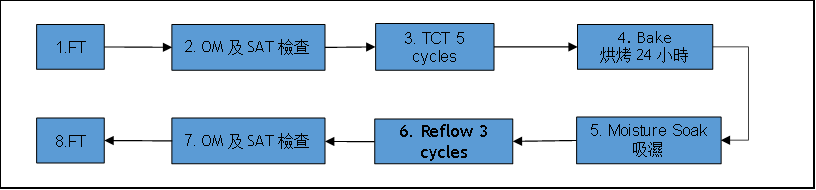 流程1、2,主要确认Pre-con前,初始的电性测试结果,以及芯片外观、内部初始状态,为Pre-con实验前的初始数据。也将会作为Pre-con实验结束后的数据比对用。 流程3,主要模拟芯片运输过程中,陆、海或空运可能经历的温度变化,然而此测项因为运输过程的不同,在规范中的定义是可以自行选择执行与否。   流程4,主要模拟芯片上板前,去除封装中的水份。使用炉温125 度烘烤24小时,确保包装拆封后芯片的状态是干燥的。 流程5,主要模拟芯片上板前,芯片包装拆封后暴露于车间的时间,相关测试条件可参考J-STD-020,Table 5-1 Moisture Sensitivity Levels。当芯片包装拆封后等待上板的时间为168 小时,车间温溼度条件为≦30 °C/60%RH的情况下。客户可以选择LEVEL 3的测试条件,以30°C/60%RH温溼度条件执行192小时的测试间,模拟该状态。  流程6,5主要模拟芯片上板时的状态,相关测试条件可参考J-STD-020;规范中的4.1 Classification Temperatures (Tc)中的Table 4-1 &4-2 ,定义封装厚度及体积选择的Tc。   规范中的Table 5-2 及Figure 5-1定义Reflow执行条件。需要执行3次Reflow,依此模拟Reflow的过程,第一次是模拟双面板A面回焊,第二次是模拟双面板B面回焊,第三次是模拟组装过程中”重工”再次回焊或是维修过程中类似回焊的温度。  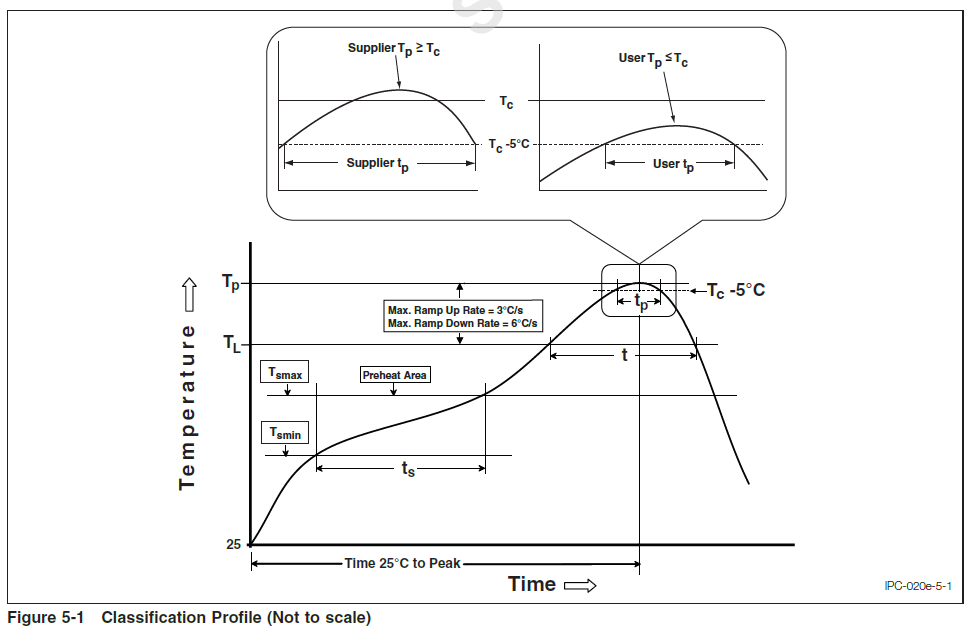 流程7、8,主要确认Pre-con后,封装内部及外观状态,以及电性测试结果,并与Pre-con实验前的数据比对。 可进一步确认Pre-con实验后内部是否有脱层或其他异常现象,外观是否有损坏,以及芯片功能是否异常。依此评估芯片组装过程中,可能面对到的失效问题。  Pre-con实验是封装可靠性测试的基础。 JESD47规范中定义”必须先执行完Pre-con实验后,才能进行THB、HAST、UHAST、TCT及AC等相关实验项目”。透过此实验加上其他各项封装可靠性测试项,让各种不同机理的潜在失效发生,进而改善工艺以确保芯片封装之可靠性。  |





