|
SEM,全称Scan Eletronic Microscope,是失效分析中非常重要的手段。
1.样品表面形貌观察(二次电子成像)
2.化学成分分析(X射线能谱仪)

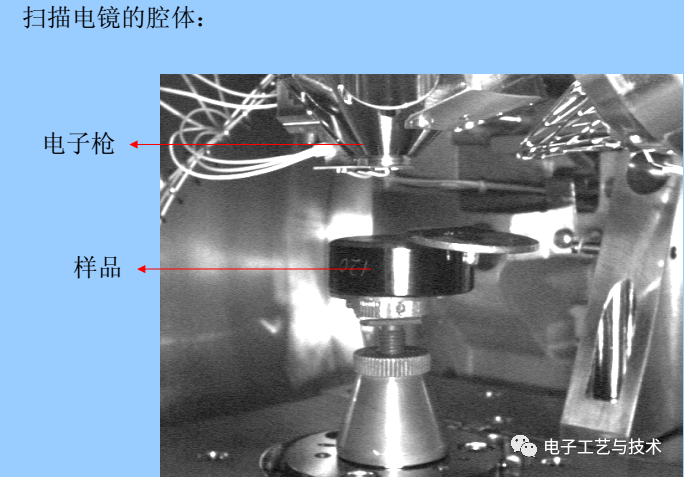
扫描电镜的成像原理:阴极加直流电压,产生电子束,经电磁透镜聚焦后形成一束直径几十埃到几千埃的电子束流,以此电子束流在样品表面进行逐行扫描,电子束轰击样品表面,激发出许多信息,分类收集就能得到各种结果。
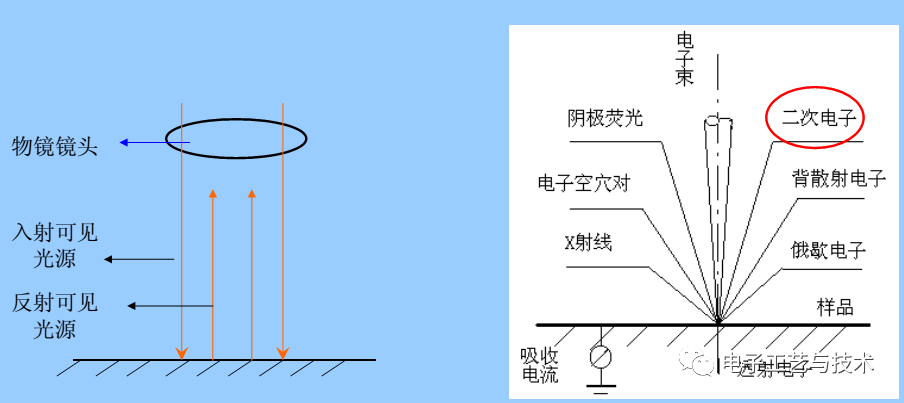
DECAP有化学开封、机械开封和激光开封,目前最常用的还是化学开封,主要针对塑封料开封, 即开盖/开帽, 指去除IC封胶, 同时保持芯片功能的完整无损, 保持Die, Bond Pads,Bond Wires或者Bond Bumps乃至Lead-Frame不受损伤, 为下一步芯片失效分析实验做准备。
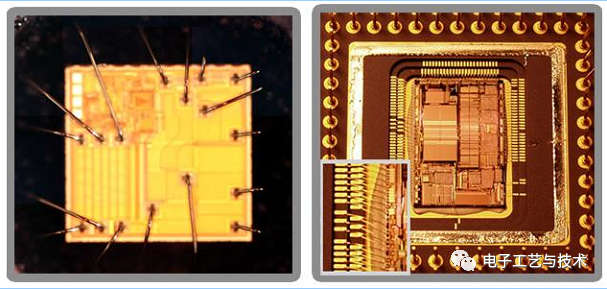
Cross-Section截面分析是芯片失效分析中的重要手段,尤其对通过Bump互联的片,例如Bump与Pad之间的结合情况只有通过Cross Section的方式才能确定。
1.芯片准备
2.芯片镶嵌(便于后续磨抛)
3.样品砂纸打磨(磨到目标截面)
4.样品抛光(去除打磨造成的损失层)
5.截面观察(光学显微镜或SEM)
★在做样品的Cross-Section前,首先需要了解样品: 目标截面在哪儿、如何得到目标截面、目标截面上的形貌分布,不清楚以上信息就着手制样就极有可能得不到自己想要的结果。
☆最简单的样品为单颗芯片,以美新Cobra芯片为例,查看Bump与Pad的
结合情况.
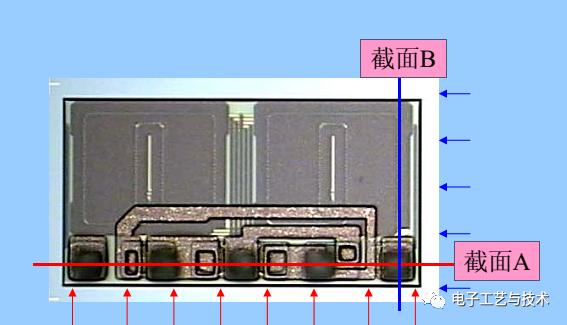
☆如果芯片被塑封料包裹,甚至多颗芯片包裹在一起,首先需要了解塑封料内的芯片分布,其次需要借助参照点来判断目标截面的位置及如何得到目标截面。
以美新Cobra塑封后的成品芯片为例,如需查看Bump与Pad的结合,需从芯片底部(基板处)向上磨到Bump位置。
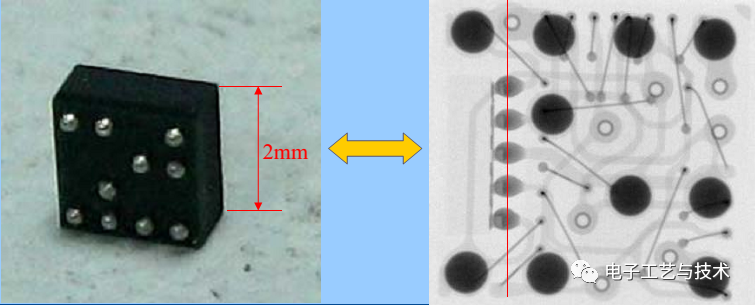
☆如果芯片比较大,如下图所示的山寨机通用的MTK主芯片,需要查看芯片中心位置的Bump连接情况,如果从一侧磨起,需要磨掉6.5mm才能达到目标截面,浪费人力及材料,此种情况可以选择— 切割。
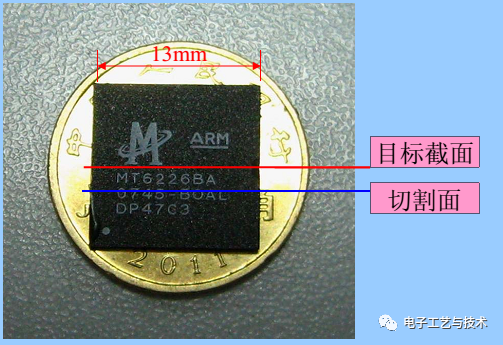
☆由于本人没有切割芯片的经验,因此以切割其他样品举例。

切割机
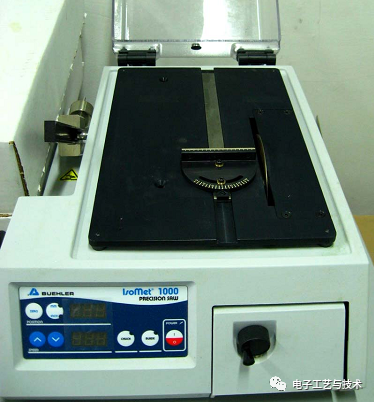
样品夹,用来固定芯片,方便后续镶嵌。

|