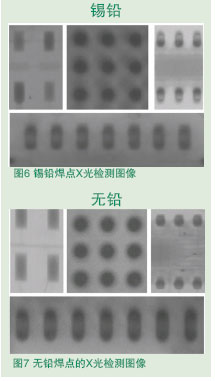 无铅测试策略 无铅测试策略1、实施无铅焊接之前对正在进行的锡铅焊接工艺建立一套完整的工艺体系。当确定了正常的缺陷水平和缺陷谱,从测试/检测角度找到瓶颈在哪里,并对无铅焊接可能产生的缺陷有了正确的预测之后,方可实施无铅导入。 2、对于有多条生产线的加工企业,应从一条生产线开始转入无铅焊接,并在该条生产线上严格执行测试/检测,充分利用分析软件进行分析。正如前面提到过的,向无铅转换的过程中,会有很多问题出现:要解决润湿性问题回流温度和波峰焊接温度的升高后器件的耐热问题工艺窗口变小的情况下回流曲线的建立问题等。一套好的工艺程序应从丝网印刷开始,加强印刷后焊膏检测,回流过程中注意预热控制;一条好的回流曲线可降低焊接缺陷,收集各工艺段的测试/检测数据,并加以分析,有助于提高生产工艺能力,降低焊接缺陷,可按缺陷增加类型调整检验标准。当所有问题得到解决,缺陷率及质量合格率可接受后,方可开始进行其他生产线向无铅工艺的转换。 3、注意,当同一条生产线从一种板型转换为另一种板型时,也会有较大的工艺变化,也许某些板型转换过程中会有少量问题出现,而其它板型的焊接缺陷会急剧升高,出现较多的问题。因此,用一条生产线作为向无铅转换的测试线,解决出现的问题,分析潜在的问题,解决产生不良影响的工艺问题,从而使所有生产线顺利转到无铅化生产。 无铅对测试/检测方法与设备的要求 焊膏检测(SPI) 更换为无铅焊膏后,印刷工艺也要做适当的调整,使用3DSPI可快速优化印刷参数,改善印刷性能。通过过去10年以上的锡铅印刷工艺参数的研究,焊膏印刷体积与焊点长期可靠性之间有着密切的关系。无铅焊膏的印刷量对无铅焊点的可靠性及其它相关问题有着同样的影响,因此,对3DSPI的需求更为迫切。对称焊盘上印刷同样体积的焊膏可以减少立碑的产生,使用3DSPI检测系统可以在焊接前预测潜在问题,对后面的回流工艺有一定的帮助,可减少实际应用中的缺陷产生,是向无铅转换中的一个重要的控制手段。 炉前,炉后AOI检测 应用AOI对焊点进行检测时,无铅与锡铅焊点的颜色稍有不同,无铅焊膏的润湿性比锡铅焊膏差,AOI检测到的无铅焊点颜色较浅,为此英国国家物理研究实验室(NPL)对六家供应商提供的AOI设备进行了测评,结果在2002年6月公布。研究表明,现有的AOI检测系统测试出的无铅与锡铅焊接结果稍有不同,但不影响对焊点好坏的判别,完全有能力对无铅PCB焊点进行检测。因此,现在大多数AOI检测设备可用于无铅检测。 AXI(自动X光检测) X光检测可以直接观察焊点图像,能否用于无铅焊接?回答是肯定的。无铅焊点产生的图像有足够的对比度来观察焊点情况,图6是使用传统的锡铅焊料的X光图像,图7是使用无铅焊料的X光图像。从两个图像中可以看出,锡铅与无铅的X光图像无太大差别,由于人类视觉对灰度的辨别能力,观察出的无铅焊点比锡铅焊点薄1520%,精确测量时可以增加这一补偿,实际观察到的焊点形状是基本相同的,因此,X光可以应用于无铅焊接的产品检测上。 ICT ICT测试基础是探针与焊盘(点)之间有良好的接触,成功检测的原理是使用硬的尖利的探针刺穿测试点上的助焊剂残留物及其它氧化物,与测试点上覆盖的焊料有良好的接触,刺穿深度由探针的材料及形状决定;刺得越深,与测试点的接触越好。 锡铅焊点的硬度大约为5000PSI,与之匹配的探针是80Z不锈钢或镀铍探头的探针,以上匹配可以达成良好接触。热风整平的PCB在测试点上已形成锡铅焊点,与探针容易形成良好接触。而适用于无铅的OSP处理的PCB表面,需要通过模板印刷,回流后形成与探针接触的测试点,测试点上焊料的多少是由模板决定的。 一般情况下,PCB文件中不包括测试点,在模板制作时要考虑到测试点的位置,否则测试点上没有焊料而成为裸铜焊盘。裸铜的伸展强度高,电迁移较铅基焊料严重,又因裸铜焊盘较薄,容易被探针刺伤。此外,OSP处理过的PCB回流后,裸铜焊盘极易氧化,造成探针与测试点之间接触性差,影响ICT测试。 因此,在无铅产品测试时,切记不可使用裸铜焊盘的测试点,制作模板时要考虑测试点上的焊膏印刷。对于OSPPCB,制作模板时要考虑测试点开孔,回流过程中,熔融焊料覆盖焊盘,令测试点与探针之间形成良好接触。 无铅焊料的延伸强度比大多数铅基焊料形成的焊点强度小,接触点会稍小一些,测试点上锡的氧化物是导体,不影响探针与测试点的接触,相对于锡铅焊料时探针必须刺穿氧化层要省力。 由于无铅焊料可焊性较差,必须选用活性强的助焊剂来提高润湿性,因此无铅焊料形成的助焊剂残留物比使用锡铅焊料要多且硬,很难被探针刺穿。当出现问题时,可与供应商联系以减少助焊剂带来的麻烦。 功能测试 无铅焊接主要是焊料要求回流温度升高,这样会增加返修对PCBA造成的潜在危害以及增加高密度PCBA的返修难度。最好的解决方法是通过功能检测校正前道生产工艺,降低过程缺陷。此外,在功能测试发现短路时,通常使用热风枪处理,否则只能更换器件。根据测试结果诊断分析,利用先进的软件功能修改测试程序,消除潜在问题,可节约返修资金。 PCBA功能测试是通过板子四周(边缘)的连接器或板针来完成的,板针测试时也有ICT测试时接触方面的问题,建议采用上述ICT处理方法。 结论 为了在2006年7月1日全面实现无铅化生产,现在向无铅转换的工艺问题正在不断得到解决。由于目前正处在一个交替阶段,不是所有的材料、器件都可以同时达到无铅要求的,这些对PCBA生产造成一定影响。因为无铅生产带来的焊接缺陷增多,测试与检测显得更加重要,好在通过一段时间的资料积累、统计和分析,表明现有的测试/检测设备基本具备无铅焊接的测试要求。 参考资料: 1.John H. Lau & Katrina Liu, “Global Trends in Lead-free Soldering”, Advanced PackagingFebruary 2004 2.NEMI http://www.nemi.org/projects/ese/tin_whisker_activities.html 3. NPL Document MATC(A)119, July 2002 http://www.npl.co.uk/ 4. SMTA Document TP-101C, 2002 http:// www.smta.org
测试与检测的主要问题 |





