MOSFET和IGBT的概念场效应管主要有两种类型,分别是结型场效应管(JFET)和绝缘栅场效应管(MOS管)。mosfet是什么意思 金属-氧化物半导体场效应晶体管,简称金氧半场效晶体管(Metal-Oxide-Semiconductor Field-Effect Transistor, MOSFET)是一种可以广泛使用在模拟电路与数字电路的场效晶体管(field-effect transistor)。 MOSFET依照其"通道"(工作载流子)的极性不同,可分为"N型"与"P型" 的两种类型,通常又称为NMOSFET与PMOSFET,其他简称上包括NMOS、PMOS等。  IGBT (Insulated Gate Bipolar Transistor),绝缘栅双极型晶体管,是由晶体三极管和MOS管组成的复合型半导体器件。  IGBT作为新型电子半导体器件,具有输入阻抗高,电压控制功耗低,控制电路简单,耐高压,承受电流大等特性,在各种电子电路中获得极广泛的应用。 从结构来说,以N型沟道为例,IGBT与MOSFET(VDMOS)的差别在于MOSFET的衬底为N型,IGBT的衬底为P型;从原理上说IGBT相当与一个mosfet和一个BIpolar的组合,通过背面P型层的空穴注入降低器件的导通电阻,但同时也会引入一些拖尾电流等问题;从产品来说,IGBT一般用在高压功率产品上,从600V到几千伏都有;MOSFET应用电压相对较低从十几伏到1000左右。  二、MOSFET和IGBT的功率区别 IGBT可以提供很大的功率、电流和电压,但是频率并不太高。目前的IGBT硬开关速度可以达到100KHZ,已经不错了。但是,相对于MOSFET的工作频率来说还是杯水车薪,MOSFET可以工作到几百KHZ、MHZ,甚至几十MHZ的射频产品。   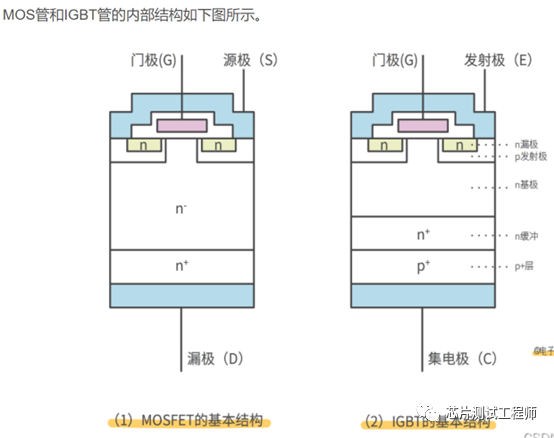 三、MOSFET和IGBT的优缺点 3.1 MOSFET MOSFET 是一个三端(栅极、漏极和源极)全控开关。栅极/控制信号发生在栅极和源极之间,其开关端为漏极和源极。栅极本身由金属制成,使用金属氧化物与源极和漏极分开。这可以减少功耗,并使晶体管成为用作电子开关或共源放大器的绝佳选择。 为了正常工作,MOSFET必须保持正温度系数。这意味着几乎没有热失控的机会。通态损耗较低,因为理论上晶体管的通态电阻没有限制。此外,由于MOSFET 可以在高频下工作,它们可以执行快速开关应用而关断损耗很小。 MOSFET 的种类很多,但最能与 IGBT 相媲美的是功率 MOSFET。它专为处理重要的功率水平而设计。它们仅在“开”或“关”状态下使用,这导致它们成为使用最广泛的低压开关。与IGBT 相比,功率MOSFET 在低电压工作时具有换流速度更快和效率更高的优点。 更重要的是,它可以维持高阻断电压并保持高电流。这是因为大多数功率MOSFET 结构都是垂直的(不是平面的)。它的额定电压是N-外延层的掺杂和厚度的直接函数,它的额定电流与沟道的宽度有关(沟道越宽,电流越高)。由于其效率,功率MOSFET 用于电源、dc/dc转换器和低压电机控制器。 3.2 IGBT IGBT也是一个三端(栅极、集电极和发射极)全控开关。它的栅极/控制信号发生在栅极和发射极之间,其开关端子是漏极和发射极。它结合了MOSFET 中的简单栅极驱动特性和双极晶体管的高电流和低饱和电压能力。它通过使用隔离栅场效应晶体管作为控制输入,使用双极功率晶体管作为开关来实现这一点。 更重要的是,IGBT专门设计用于快速开启和关闭。事实上,它的脉冲重复频率实际上进入了超声波范围。这种独特的能力是为什么IGBT 经常与放大器一起使用,以利用脉宽调制和低通滤波器合成复杂波形。它们还用于在粒子和等离子体物理学等领域产生大功率脉冲,并在电动汽车、火车、变速冰箱、空调等现代电器中发挥作用。更多详细信息,请参阅本文“ MOSFET 与IGBT ”。 四、MOSFET和IGBT的应用特点 至于它的应用,根据它的特点:MOSFET用于开关电源(可以看这篇论文《大功率可调开关电源的工作原理》,镇流器,高频感应加热,高频逆变焊接机、通讯电源等高频电源,IGBT专注于焊接、逆变器、逆变器、电镀电源、超音频感应加热等领域。 开关电源(SMPS) 的性能在很大程度上取决于功率半导体器件的选择,即开关和整流器。 MOSFET开关电源 虽然对于选择IGBT 或MOSFET 的问题并没有全面的解决方案,但比较IGBT 和MOSFET 在具体SMPS 应用中的性能,仍然可以确定关键参数的范围。 MOSFET和 IGBT 中的V 传导损耗 除了IGBT 压降更长之外,IGBT和功率 MOSFET 的导通特性非常相似。从基本的IGBT 等效电路(见图1)可以看出,PNP BJT 集电极基区的少数载流子完全调整所需的时间导致电压拖尾电压的出现。 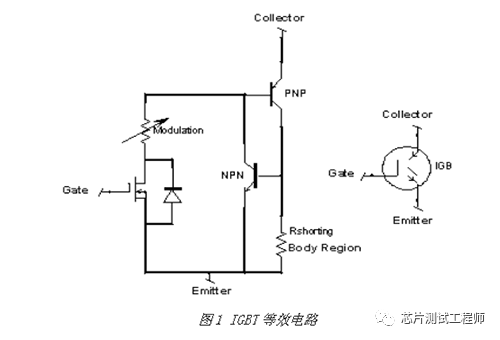 图1:IGBT 等效电路 这种延迟会导致准饱和效应,因此集电极/发射极电压不会立即降至其 VCE (sat) 值。当负载电流从封装的并联、反并联二极管切换到IGBT 的集电极时,这种效应还会导致ZVS 情况下的VCE 电压升高。 IGBT 数据表中列出的 Eon 能耗是每个转换周期的 Icollector 和VCE 乘积的时间积分,单位为焦耳,并且包含与等级饱和相关的额外损耗。它进一步分为两个Eon能量参数,Eon1和Eon2。Eon1 不包括与硬开关二极管损耗相关的功率损耗,而Eon2 包括与二极管恢复相关的硬开关开通能量,可以通过恢复与二极管封装二极管相同的二极管来测量。 通常,Eon2测试电路如图 2 所示。IGBT 通过使用两个脉冲打开和关闭来测量Eon。第一个脉冲将增加电感电流以达到所需的测试电流,然后第二个脉冲将测量测试电流在二极管上恢复时的Eon 损耗。 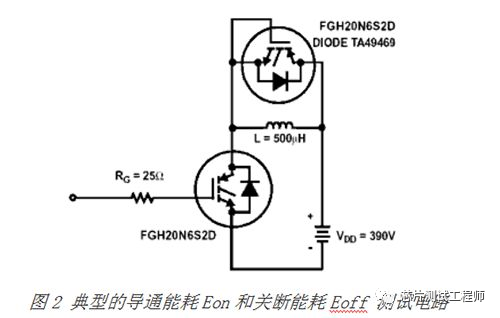 图2:典型的导通能量Eon 和关断能量Eoff 测试电路 Eon 开关损耗由栅极驱动电压和阻抗以及硬开关导通时整流二极管的恢复特性决定。对于传统的CCM升压PFC电路,升压二极管恢复特性在Eon(on)能耗控制中极为重要。除了选择具有最小Trr 和QRR 的升压二极管外,确保二极管具有软恢复特性也很重要。柔软度,即tb / ta 的比率,对开关器件产生的电噪声和电压尖峰有相当大的影响。 一些高速二极管在时间tb 期间 IRM (REC) 的电流下降率(di/dt) 很高,从而在电路的寄生电感中产生高电压尖峰。这些电压尖峰会导致电磁干扰(EMI),并可能导致二极管上的反向电压过高。 在全桥和半桥拓扑等硬开关电路中,采用IGBT 封装的封装是快速恢复晶体管或MOSFET 体二极管。当相应的开关导通时,二极管有电流流过,二极管的恢复特性决定了Eon损耗。因此,选择具有快速体二极管恢复特性的MOSFET 非常重要。不幸的是,MOSFET的寄生二极管或体二极管的恢复特性比目前业界使用的分立二极管要慢。因此,对于硬开关MOSFET 应用,体二极管通常是决定SMPS 工作频率的限制因素。 通常,选择IGBT 封装二极管以匹配其应用,具有较低正向传导损耗的较慢超快二极管和较慢的低VCE (sat) 电机驱动IGBT 封装。相比之下,软恢复超快二极管可以与高频SMPS2 开关模式IGBT 组合进行封装。除了选择合适的二极管外,设计人员还可以通过调整栅极驱动导通源阻抗来控制Eon 损耗。降低驱动源阻抗将增加IGBT 或MOSFET 的开/关并降低 Eon 损耗。Eon 损耗和 EMI 需要妥协,因为更高的 di/dt 会导致电压尖峰,增加辐射和传导EMI。为了选择正确的栅极驱动阻抗以满足开通di/dt 要求,可能需要对电路进行内部测试和验证。 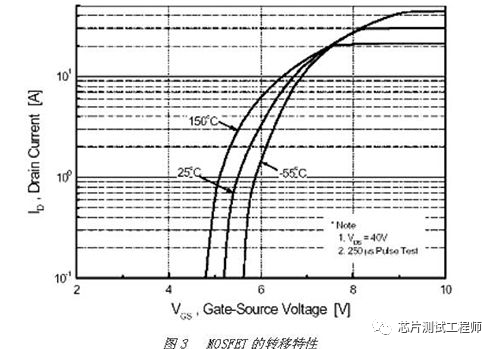 图3:MOSFET 传输特性 假设FET 电流在导通时上升到10 A,则栅极电压必须从5.2 V 过渡到6.7 V,才能根据图3 中 25 °C 时的曲线达到 10 A 的值,平均 GFS 为 10 A / (6.7 V- 5.2V) = 6.7mΩ。  等式1 得出所需 on di / dt 的栅极驱动阻抗 将平均GFS 值应用于公式1 会导致栅极驱动电压Vdrive = 10V,所需的di / dt = 600A / μs,FCP11N60的 VGS (avg) = 6V 和Ciss = 1200pF 的典型值;栅极驱动阻抗为37Ω。由于瞬态 GFS 值在图 3 的图表中是一条对角线,因此在Eon 期间会发生变化,这意味着di / dt 也会发生变化。指数衰减的栅极驱动电流Vdrive 和下降的Ciss 也作为VGS 的函数进入公式,呈现出令人惊讶的线性电流上升的整体效应。 类似地,可以对IGBT 执行类似的栅极驱动导通电阻计算。VGE (avg) 和GFS 可以由IGBT 开关特性确定,并且使用VGE (avg) 处的CIES 值代替Ciss。计算得到的IGBT开通栅极驱动阻抗为100Ω,高于之前的37Ω,说明IGBT GFS越高,CIES越低。这里的关键点是,为了从MOSFET 切换到IGBT,必须调整栅极驱动电路。 六、传导损耗详解 与额定电压为600V 的器件相比,IGBT通常比相同芯片尺寸的600V MOSFET 具有更少的传导损耗。当集电极和漏极电流密度被清楚地检测到并且在最坏的情况下工作结温时,应该进行这种比较。例如,FGP20N6S2 SMPS2 IGBT 和FCP11N60 SuperFET 的RθJC 值为1°C/W。图4 显示了结温为 125°C 时导通损耗与直流电流的关系。MOSFET 在直流电流大于2.92A 时更大。 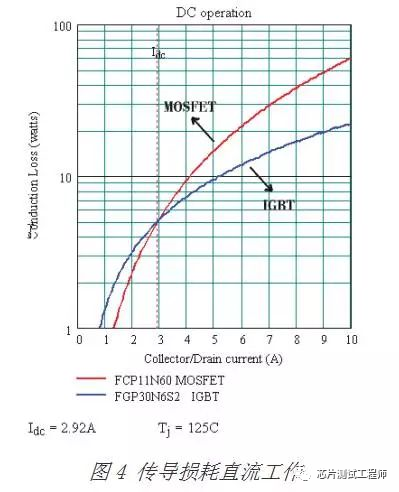 图4:传导损耗 DC 工作 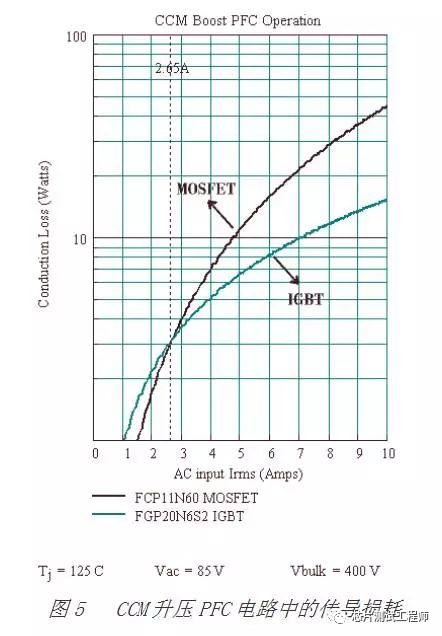 图 5:CCM 升压 PFC 电路中的传导损耗 然而,图4 中的直流传导损耗不太适合大多数应用。同时,图5 显示了 CCM(连续电流模式)、升压 PFC 电路、125°C 结温以及 85V 交流输入电压 Vac 和 400Vdc 直流输出电压工作模式下的传导损耗比较。图中,MOSFET-IGBT的曲线交叉点为2.65A RMS。对于 PFC 电路,当交流输入电流大于 2.65A RMS 时,MOSFET的传导损耗更大。2.65A PFC 交流输入电流等于MOSFET 中通过公式2 计算的 2.29A RMS。计算 MOSFET 传导损耗 I2R、公式 2 定义的电流以及 125°C 时 MOSFET 的 RDS (on)。将 RDS (on)考虑到漏极电流的变化,可以进一步细化导通损耗,如图6 所示。 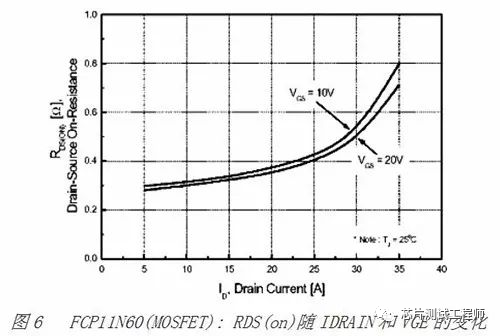 图6:FCP11N60 (MOSFET):RDS (on) 与IDRAIN 和VGE 变化 在MOSFET 传导非常小的占空比的高脉动电流拓扑中,应考虑图6 所示的特性。如果FCP11N60 MOSFET 工作在一个漏极电流为20A 脉冲(即5.5A RMS)且占空比为7.5% 的电路中,则有效RDS (on) 将小于5.5A(数据表中的测试电流)0.32 欧姆大25%。  公式2 CCM PFC 电路中的RMS 电流 在公式2 中,Iacrms 是 PFC 电路 RMS 输入电流;Vac 为 PFC 电路 RMS 输入电压;Vout 是直流输出电压。 在实际应用中,计算类似PFC 电路中IGBT 的导通损耗会更加复杂,因为每个开关周期是在不同的IC 上执行的。IGBT的VCE(sat)不能用单一阻抗来表示。更简单直接的方法是将其表示为与固定VFCE 电压串联的电阻器RFCE,VCE (ICE) = ICE × RFCE + VFCE。然后可以将传导损耗计算为平均集电极电流和VFCE 的乘积,加上RMS 集电极电流的平方,再乘以阻抗RFCE。 图5 中的示例仅考虑了CCM PFC 电路的传导损耗,对于最差传导情况的设计目标,假设其小于15W。以FCP11N60 MOSFET为例,该电路限制在5.8A,FGP20N6S2 IGBT可以在9.8A交流输入电流下工作。它传导 70% 以上的MOSFET 功率。 尽管IGBT 具有低传导损耗,但大多数600V IGBT 是PT(穿通)器件。PT 器件具有 NTC(负温度系数)特性,不能并联。或许,这些器件可以通过匹配器件VCE (sat)、VGE (TH)(栅极触发阈值电压)和机械封装来实现有限的并联,从而使IGBT 芯片的温度保持恒定不变。相比之下,MOSFET具有 PTC(正温度系数),可提供良好的电流分流。 总结两者区别 1.由于MOSFET的结构,通常它可以做到电流很大,可以到上KA,但是前提耐压能力没有IGBT强。 2.IGBT可以做很大功率,电流和电压都可以,就是一点频率不是太高,目前IGBT硬开关速度可以到100KHZ,那已经是不错了.不过相对于MOSFET的工作频率还是九牛一毛,MOSFET可以工作到几百KHZ,上MHZ,以至几十MHZ,射频领域的产品. 3.就其应用,根据其特点:MOSFET应用于开关电源,镇流器,高频感应加热,高频逆变焊机,通信电源等等高频电源领域;IGBT集中应用于焊机,逆变器,变频器,电镀电解电源,超音频感应加热等领域。 |





