1.二极管的测试二极管作为集成电路chip中重要的功能部分,对于n型二极管,它是两端器件,它的两个端口阴极(n型有源区)和阳极(PW)分别连到PAD_N和PAD_P。对于p型二极管,它是二端器件,它的二个端口阴极(p型有源区)和阳极(NW)分别连到PAD_P和PAD_N。WAT测试机器通过这二个端口把电压激励信号加载在二极管两端,从而测得所需的电性特性参数数据。 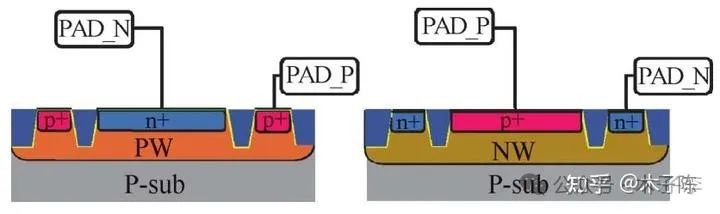 二极管的测试参数电容(Cjun)和击穿电压(BVjun) · 电容(Cjun) 测量n型二极管和p型二极管的结电容Cjun的基本原理是在二极管的一端加载AC 100kHz扫描电压,另一端接地,从而测得电容C,Cjun=C/Area,Area是电容的面积。 测量n型二极管结电容Cjun的基本方法是首先在n型二极管的一端n型有源区上加载AC 100kHz(VDD或者VDDA)扫描电压,另一端PW上接地,从而测得电容C,Cjun=C/Area。 测量p型二极管结电容Cjun的基本方法是首先在p型二极管的一端NW衬底上加载AC 100kHz(VDD或者VDDA)扫描电压,另一端p型有源区上接地,从而测得电容C,Cjun=C/Area。  · 击穿电压(BVjun) 击穿电压(BVjun测量n型二极管和p型二极管的击穿电压BVjun的基本原理是在二极管的一端加载反向电压,另一端接地,从而测得漏电流Ib,得到单位面积电流强度Ib/Area,当电流强度达到100pA/μm2时,pn结被电压击穿。 影响二极管的因素包括以下几方面:1)阱离子注入异常;2)n+或者p+离子注入异常;3)离子注入损伤在退火过程中没有激活;4)AA刻蚀尺寸异常。 2.CMOS工艺技术平台的电容的测试 CMOS工艺技术平台的电容包括MIM和PIP(Poly Insulator Poly)和MOM(Metal Oxide Metal)。PIP主要应用在0.35μm及以上的亚微米及微米工艺技术,MIM主要应用在0.35μm及以下的深亚微米工艺技术,纳米工艺技术会用到MOM。下图为常见的PIP与MIM 版图 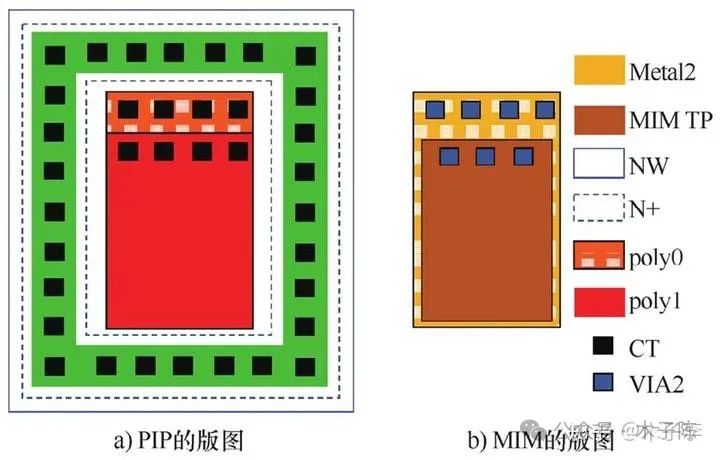 它们的两个端口是上极板(Top)和下极板(Bottom)分别连接到PAD_P1和PAD_P2。为了更好地与衬底隔离,PIP测试结构是设计在NW里,NW连接到PAD_B,PAD_B接地。衬底对MIM的影响非常小,把MIM测试结构设计在PW里,WAT测试机器通过上极板和下极板这两个端口把电压激励信号加载在MIM和PIP,从而测得所需的电性特性参数数据。 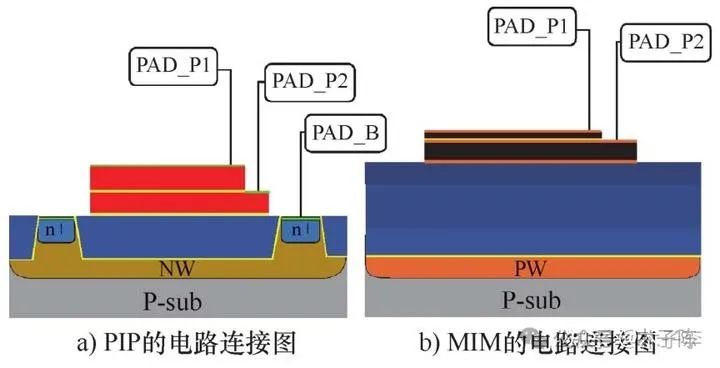 MIM和PIP电容是设计混合信号电路的重要器件,它们的准确性严重影响电路性能,芯片代工厂通过两个WAT参数监测MIM和PIP,这两个WAT参数分别是电容C和击穿电压BV。 · 电容C 基本原理是在电容的上极板加载100kHz扫描电压,下极板接地,从而测得电容C,Cjun=C/Area,Area是电容的面积。 · 击穿电压BV 与测量MOS晶体管器件栅极氧化层击穿电压类似,基本原理在电容的上极板加载DC扫描电压,另一端接地,从而测得漏电流Ib,得到单位面积电流强度为Ib/Area,当电流强度达到100pA/μm2时,电容被电压击穿,此时加载在电容两端的电压就是击穿电压。 · 影响因素 1.PIP和MIM的电介质厚度异常 2.PIP和MIM的刻蚀尺寸异常; |





