|
在晶圆测试过程中,难免会出现一些异常问题,其中“探针(Probe needle)烧针现象”是个较严重的测试异常。由于探针针尖与电源PAD 接触面积较小,数百毫安(mA)电流会将探针针尖氧化,这被称为烧针。该文通过案例分析,烧针现象和针尖清针的必然联系以及为了避免烧针,程序开发方面的一些注意事项。 0 引言 IC 测试分为晶圆测试(Circuit Probing) 和成品测试(Final Testing)。晶圆测试的原理如图1 所示,将测试系统的资源连接到圆片级集成电路上的方法如下:根据圆片制造PAD 点的间距制作针卡,将针卡置于探针台上,通过设置探针台,使得针卡扎到电路的PAD 点上,在针卡及DUT 上焊上羊角,插在测试系统的母版上,集成电路测试系统将内部的PEB、DPS、BPMU、PPMJU 等通道、电源的测试资源连接外置的母版上,即可实现测试系统的资源和集成电路的连接。 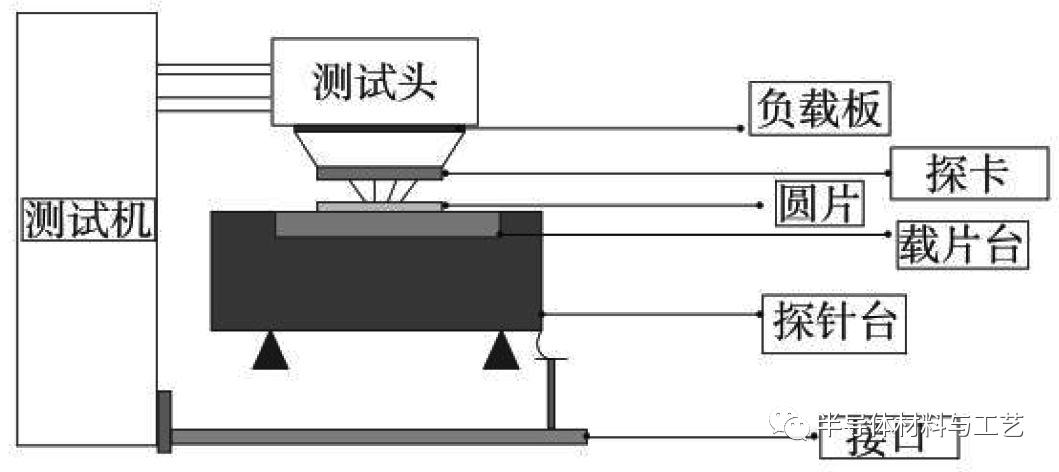 图1 晶圆测试原理图 在实际生产过程中,晶圆测试受整个系统设计的影响较大,可变因素较多,难免会出现些许异常,其中“探针烧针现象”是个较严重的测试异常。出现烧针后,处理方法是必须把针尖上黏附的氧化物去除干净,但这样会磨损一部分针尖,导致针尖变短。由于针尖变短,要把所有探针重新研磨至同一水平面,也就是所有探针针尖一起做了缩短,影响了整张探针卡的使用寿命,烧针严重的,针卡无法使用只能报废,需重新制针,既增加了制作成本,又影响了生产进度,所以如何有效防范烧针成为测试工程师的巨大挑战。 1 问题描述 某产品,抽检时发现一片晶圆在测试完后,管芯PAD 上(VDD pin)有扎针由于烧针出现漏氧异常,约占此片抽样数的20%左右,抽测异常位置在1-5 区域,如图2 所示。  图2 测试异常现象 2 问题分析 处理此问题,我们从最常用的人、机、料、法、环来考虑发生现象的可能性,如图3 所示。  图3 鱼骨图分析 从鱼骨图分析,最有可能出现异常的四个地方分别是:操作员调错程序、产品本身工艺问题、清针(needleclean)不到位、测试程序异常。 2.1 调错程序 操作人员都是按照流程卡进行操作,追溯了历史记录及测试数据,并无发现有异常现象发生,且操作流程与其他正常批次流程相同,由此可见,操作人员并不是造成此异常的真正原因。 2.2 产品本身工艺问题 测试前有来料检验,未发现问题,查看同批次其他晶圆,并未发现有类似现象发生,由此可见,产品本身没有工艺上的缺陷,此可能排除。 2.3 清针不到位 探针卡长时间测试后,针尖会吸附污染物和铝屑,大大增加了针尖的电阻,从而降低了针尖所能承受的电流,如负载较大,针尖积攒的能量过大,会引起烧针。 2.4 测试程序优化 测试程序是由工程师进行编写,程序中如有未知的错误隐患,也是会有可能出现烧针现象的发生。对程序进行优化从而来避免烧针现象的出现,这个也是作为一名产品工程师需要考虑的。 3 问题解决 3.1 清针的重要性 清针真的这么重要吗?和烧针现象是否有关系?我们先从探针卡说起,IC 探针卡(probe card),是用于测试晶圆(wafer)良品率的工具,按针的材质可分为以下几种,如表1 所示。  晶圆测试时,探针需要接触到芯片PAD 上,而芯片PAD 开口尺寸现在一般是60 μm×60 μm,探针针尖直径一般在15 μm 左右。当探针进行长时间测试之后,探针的针尖会被氧化,从而增加了瞬时阻抗。所以在测试过程中,会在探针台(Prober)里设置清针每扎管芯500次清针一次(500 touchdown),当然具体设定值因测试的产品不同,可适当调整清针频率)。从而清除针尖上的沾到的污染物、铝屑等杂质。图4 所示为探针上的杂质。  图4 探针上的杂质 |





